先进封装的未来在哪里?
2019-03-22
09:54:53
来源: 互联网
点击
SiP被视为是实现超越摩尔定律的重要路径之一,它是将多种功能芯片,包括处理器、存储器等功能芯片集成在一个封装内,从而实现一个基本完整的功能。与SiP相对应,SoC也是超摩尔定律下逐渐发展起来的又一股势力。在摩尔定律疲软的状态下,市场开始对这两种技术进行了讨论。
3月21日,SEMICON CHINA 2019同期举办的先进封装——异构集成论坛,邀请了来自异构封测、设备和材料行业的专家,分享先进封装领域的挑战以及在封装解决方案中的宝贵经验,并共同探讨了未来异构集成先机封装技术发展的路线图。
本届论坛由华为高级技术顾问符会利博士主持。
江苏长电科技高级副总裁梁新夫进行了以“先进SiP技术及应用的发展”为主题的演讲,他表示:“发展SiP的挑战在于如何提高芯片性能、实现小型以及降低成本。”同时,他还介绍了长电科技在汽车领域中SiP封装的进展。

针对SiP,联发科技副总经理高学武对此也有话说,他与参会者分享了以“异构产品定制:超越摩尔的集成方案”为主题的演讲,他将SiP比喻成为鸡尾酒,认为SiP可以适应用户的不同需求而研发。他认为,SiP和SOC将相互触发以形成正循环,Fan-Out是Foundry和OSAT的交汇点。同时,他也表示,MTK在SiP技术上的两个重点方向是5G和Networking。

ASE日月光集团资深处长冯耀信以“先进封装最新内连接技术——扇出型封装”为演讲主题,介绍了日月光扇出型封装的内连接技术。在他的演讲中,冯耀信介绍道:“ASE的Fan out 封装产品线主要包含aWLP、FOCos、M-Serirs、FOPoP、FOSiP、Panel FO。FO已经在移动(RF/PMIC/AP)和Networking(ASIC/ASIC)上得以应用,同时,基于高可靠性的品质,也让M-Serirs得到了认可。”
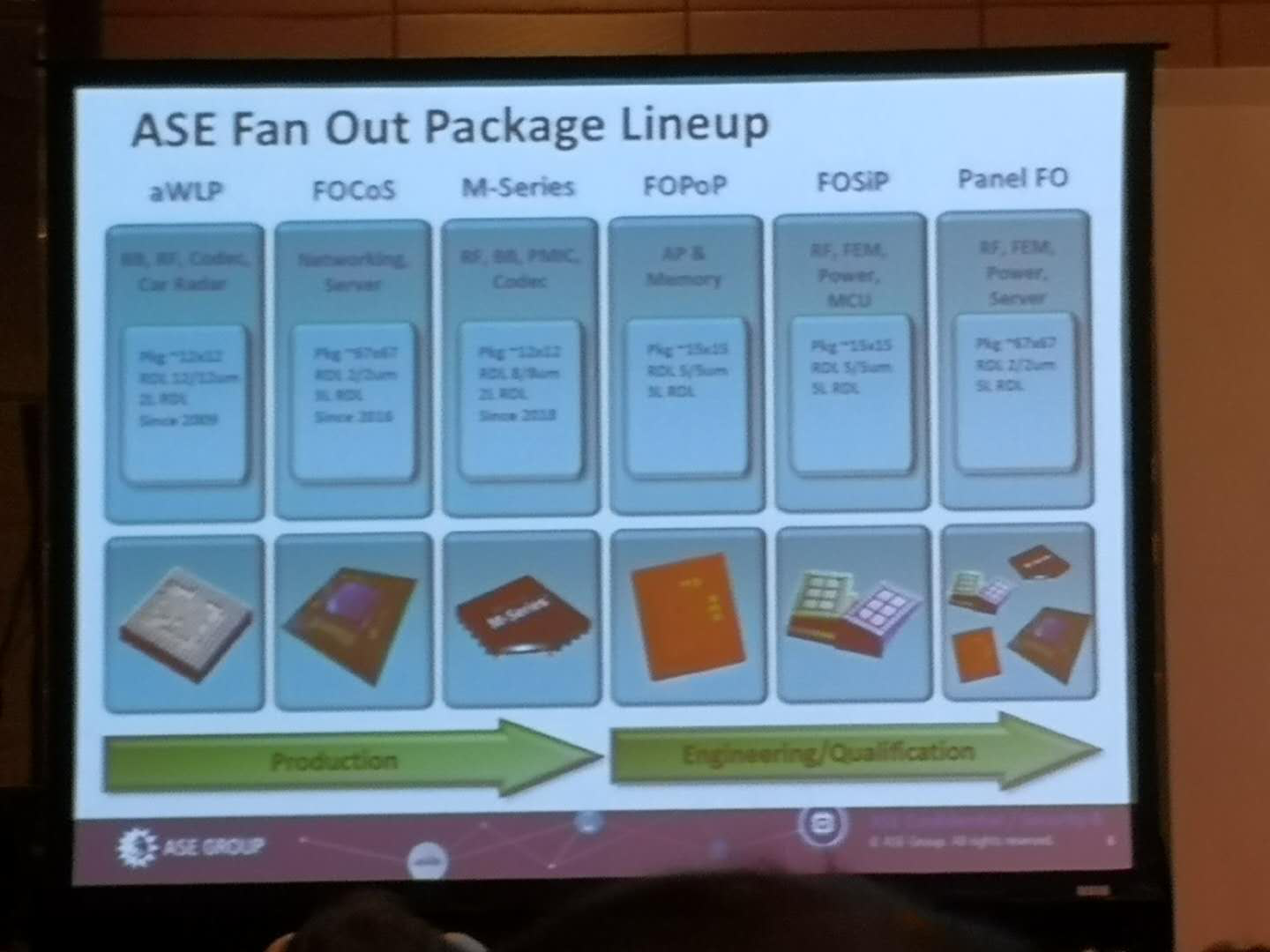
先进封装的发展,不仅在于封装技术的进步,同样也带动了设备、材料的演进。慧瞻材料科技,全球表面清洗和处理副总裁陈天牛针对IC产业链的现状,肯定了封装行业的价值,并进行了以“开发引领先进半导体封装的湿法蚀刻和清洗液”为主题的演讲,强调了清洗设备对先进封装的重要意义。

苏州晶方半导体市场和业务拓展副总经理刘宏钧则以“利用封装集成技术应对CMOS缩微调整”为主题发表了演讲,他认为AI和IoT都推动了类似Fan-Out等先进封装的发展,但是,无论是WLP、FO还是SiP未来先进封装的发展都将归向于3D封装。同时,他表示,在这种情况下,降低成本和提高产量也仍然是晶方科技面临的挑战。

正如前面所提到的,从应用层面上看,先进封装的驱动力在于AI、自动驾驶等方面的发展,就此趋势。矽品总监Jensen Tsai 以“SiP异构集成”为主题进行了演讲,他认为:“大型SiP模块适用于采用2.5D或是Fan-Out的HPC、AI以及汽车电子等应用,更小的SiP模块主要用于移动,可穿戴消费类设备。”

LAM Research董事总经理Manish Ranjan进行了以“先进封装对下一代半导体器件开发密切相关”的演讲,他表示:“高级封装正成为解决下一代系统级需求的关键技术推动者。内存和前沿逻辑芯片都在推动先进封装解决方案的发展。LAM Research是市场领先的可信赖设备供应商,提供一流的技术和生产力解决方案”
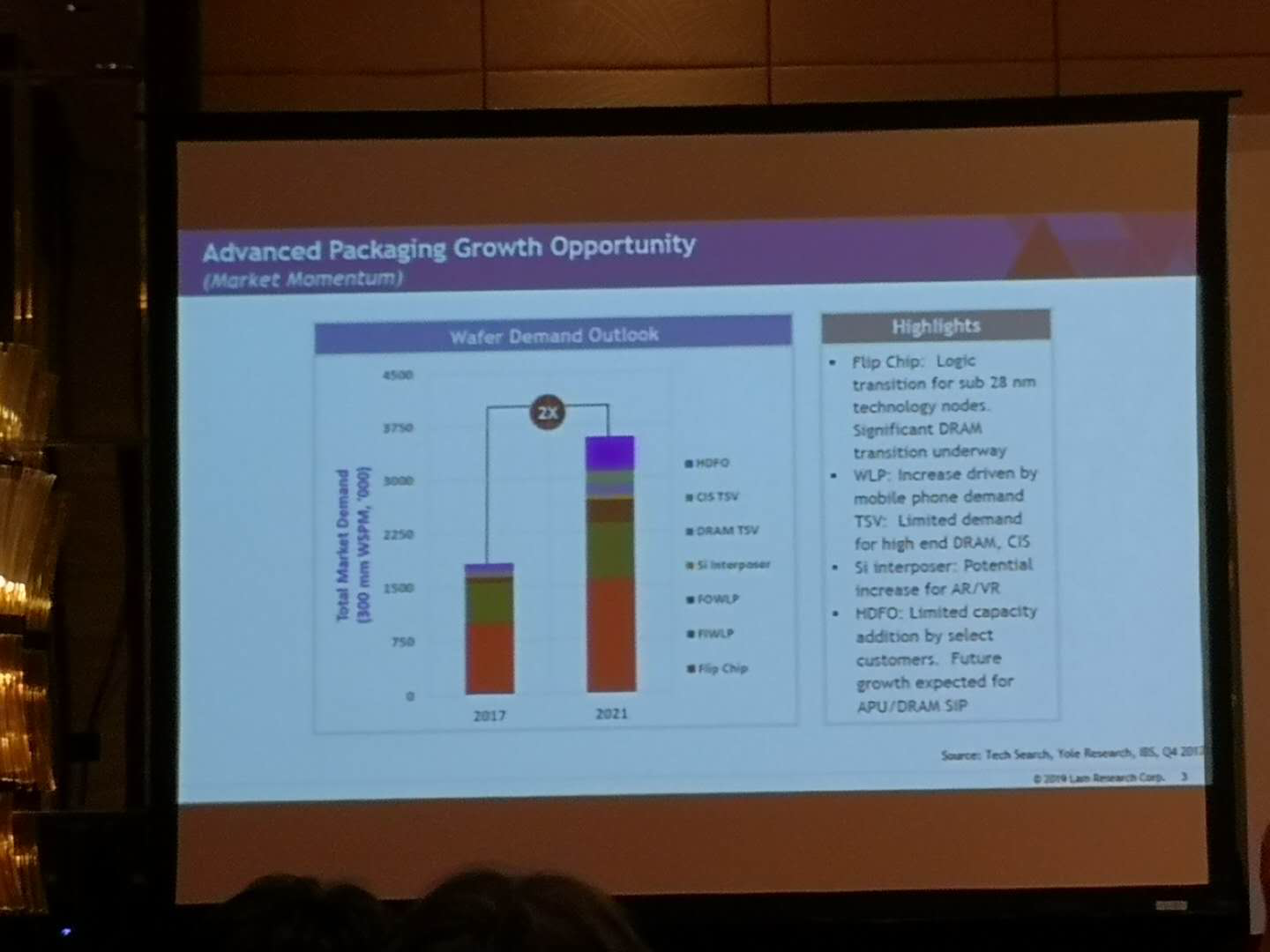
TechSearch的代表以“异构集成路线图”为主题的演讲,结束了本届先进封装论坛 - 异构集成。她表示:“异构集成是满足未来15年电子技术难题的关键能力。如果没有此功能,则无法在保持可靠性的情况下将系统迁移到封装中。”

3月21日,SEMICON CHINA 2019同期举办的先进封装——异构集成论坛,邀请了来自异构封测、设备和材料行业的专家,分享先进封装领域的挑战以及在封装解决方案中的宝贵经验,并共同探讨了未来异构集成先机封装技术发展的路线图。
本届论坛由华为高级技术顾问符会利博士主持。
江苏长电科技高级副总裁梁新夫进行了以“先进SiP技术及应用的发展”为主题的演讲,他表示:“发展SiP的挑战在于如何提高芯片性能、实现小型以及降低成本。”同时,他还介绍了长电科技在汽车领域中SiP封装的进展。

针对SiP,联发科技副总经理高学武对此也有话说,他与参会者分享了以“异构产品定制:超越摩尔的集成方案”为主题的演讲,他将SiP比喻成为鸡尾酒,认为SiP可以适应用户的不同需求而研发。他认为,SiP和SOC将相互触发以形成正循环,Fan-Out是Foundry和OSAT的交汇点。同时,他也表示,MTK在SiP技术上的两个重点方向是5G和Networking。

ASE日月光集团资深处长冯耀信以“先进封装最新内连接技术——扇出型封装”为演讲主题,介绍了日月光扇出型封装的内连接技术。在他的演讲中,冯耀信介绍道:“ASE的Fan out 封装产品线主要包含aWLP、FOCos、M-Serirs、FOPoP、FOSiP、Panel FO。FO已经在移动(RF/PMIC/AP)和Networking(ASIC/ASIC)上得以应用,同时,基于高可靠性的品质,也让M-Serirs得到了认可。”
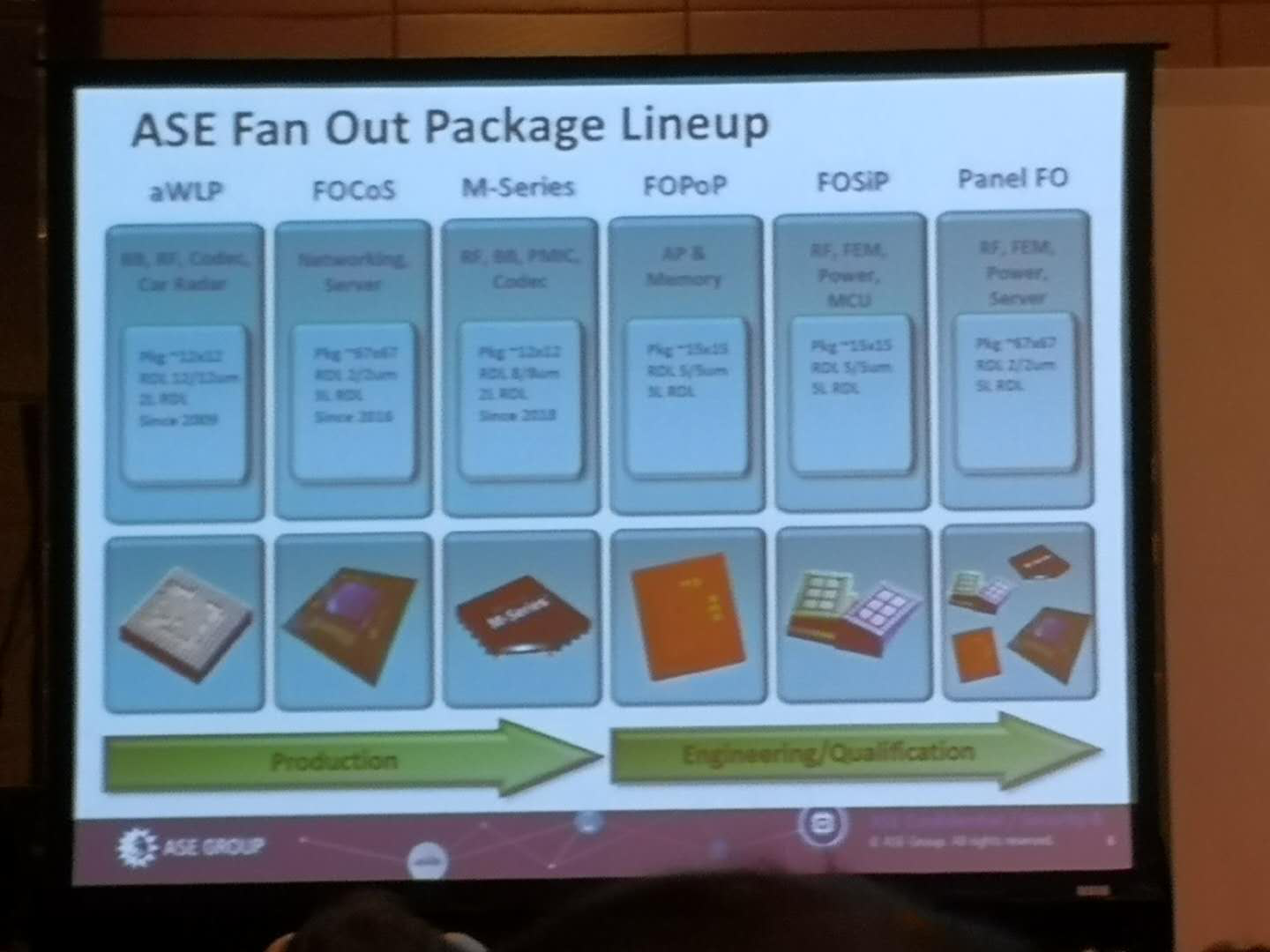
先进封装的发展,不仅在于封装技术的进步,同样也带动了设备、材料的演进。慧瞻材料科技,全球表面清洗和处理副总裁陈天牛针对IC产业链的现状,肯定了封装行业的价值,并进行了以“开发引领先进半导体封装的湿法蚀刻和清洗液”为主题的演讲,强调了清洗设备对先进封装的重要意义。

苏州晶方半导体市场和业务拓展副总经理刘宏钧则以“利用封装集成技术应对CMOS缩微调整”为主题发表了演讲,他认为AI和IoT都推动了类似Fan-Out等先进封装的发展,但是,无论是WLP、FO还是SiP未来先进封装的发展都将归向于3D封装。同时,他表示,在这种情况下,降低成本和提高产量也仍然是晶方科技面临的挑战。

正如前面所提到的,从应用层面上看,先进封装的驱动力在于AI、自动驾驶等方面的发展,就此趋势。矽品总监Jensen Tsai 以“SiP异构集成”为主题进行了演讲,他认为:“大型SiP模块适用于采用2.5D或是Fan-Out的HPC、AI以及汽车电子等应用,更小的SiP模块主要用于移动,可穿戴消费类设备。”

LAM Research董事总经理Manish Ranjan进行了以“先进封装对下一代半导体器件开发密切相关”的演讲,他表示:“高级封装正成为解决下一代系统级需求的关键技术推动者。内存和前沿逻辑芯片都在推动先进封装解决方案的发展。LAM Research是市场领先的可信赖设备供应商,提供一流的技术和生产力解决方案”
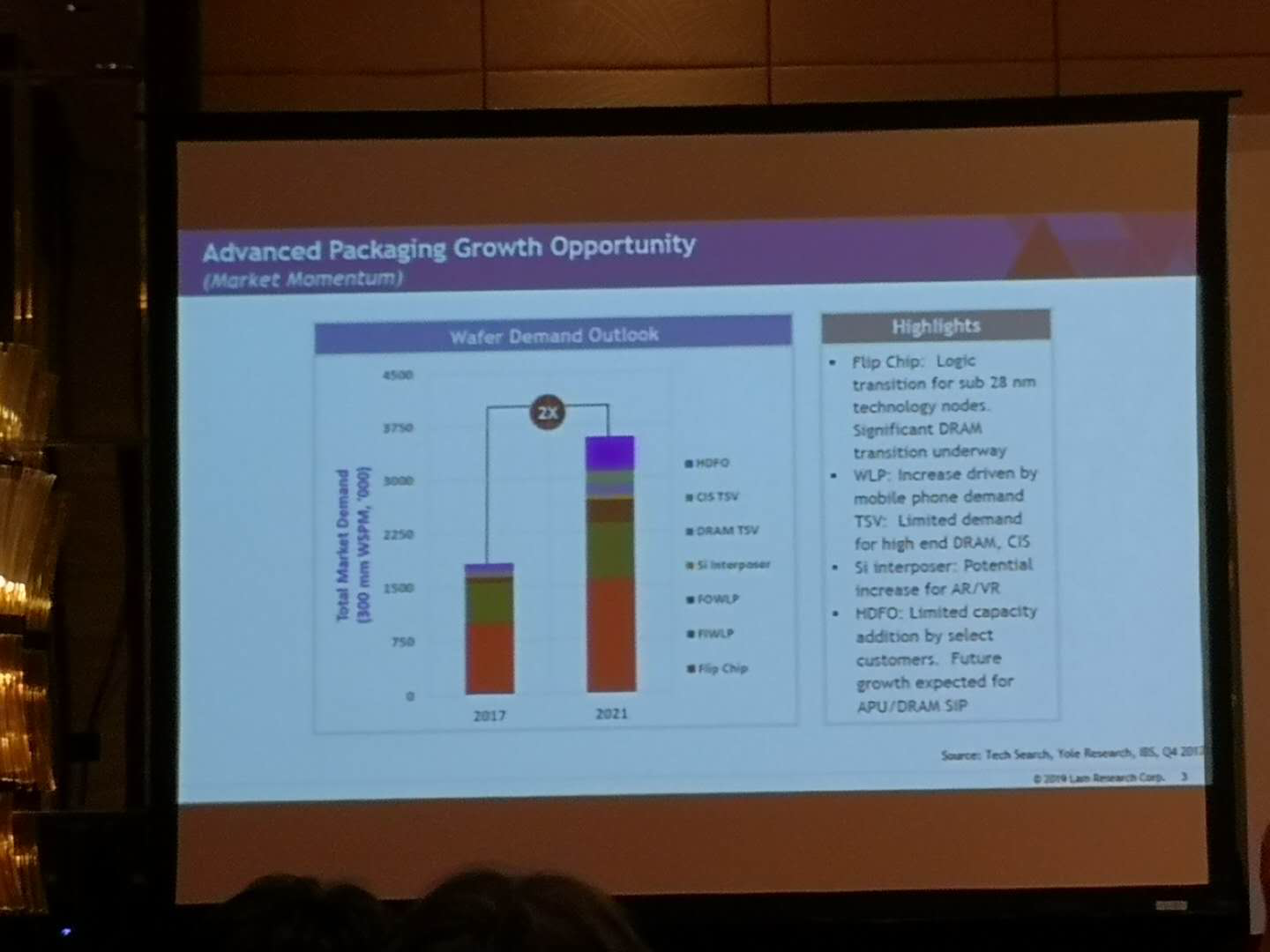
TechSearch的代表以“异构集成路线图”为主题的演讲,结束了本届先进封装论坛 - 异构集成。她表示:“异构集成是满足未来15年电子技术难题的关键能力。如果没有此功能,则无法在保持可靠性的情况下将系统迁移到封装中。”

责任编辑:sophie
相关文章
-

- 半导体行业观察
-

- 摩尔芯闻
