盛美半导体推出半关键清洗系列设备,拓宽Ultra C产品链
2020-05-09
10:46:25
来源: 盛美半导体设备
点击
扩大盛美公司产品组合
为客户提供更多价值
作为集成电路制造与先进晶圆级封装(WLP)领域中领先的设备供应商,盛美半导体设备(NASDAQ:ACMR)近日发布了三款用于晶圆正、背面清洗工艺的Ultra C湿法清洗系列设备。
这一系列设备包括晶圆背面清洗设备Ultra C b,自动槽式湿法清洗设备Ultra C wb,和刷洗设备Ultra C s,它们将盛美创新的湿法工艺技术扩展到了更广泛的应用领域。
“我们中国的客户要求盛美除了提供应用于关键工艺步骤中前沿的主打产品之外,也为他们提供其他的非前沿设备,我们称之为 “半关键设备”。这套设备可以提供高质量的工艺,以支持客户生产链中要求不那么高,但仍然相当重要的步骤,”盛美半导体设备董事长王晖表示。“我们开发的Ultra C系列产品满足了这一要求,扩展了产品链实现一站式服务,同时也为客户提供了更有竞争力的产品。”
这三款Ultra C系列新产品的目标市场是先进集成电路领域,功率器件领域和先进晶圆级封装(WLP)领域。晶圆背面清洗Ultra C b和槽式湿法清洗Ultra C wb设备现已在中国先进半导体厂的量产中证明了它们的优势。首台刷洗设备Ultra C s也已在2020年第一季度交付中国客户,在验收合格后即可确认收入。
晶圆背面清洗设备
晶圆背面清洗设备

Ultra C b
Ultra C b是一款高性价比的晶圆背面清洗设备,具有良好的颗粒管控能力和刻蚀均匀性控制能力,该设备三大关键应用分别为晶圆背面清洗工艺,如金属去除或RCA清洗;晶圆背面湿法硅刻蚀工艺,如晶圆背面湿法减薄或湿法硅通孔露出(TSV reveal);以及晶圆回收工艺中的多晶硅层、氧化层和氮化层等膜层剥离去除。该设备可处理高翘曲度晶圆,适用于处理200毫米或300毫米超薄晶圆和键合晶圆。
进行晶圆背面清洗时,使用传统的夹具有可能对晶圆正面会带来损伤,该设备的晶圆夹具与传统的夹持方式不同,它利用了伯努利效应,使晶圆悬浮于晶圆夹具上,而晶圆正面与夹具间无物理接触。当清洗化学药液喷淋到晶圆背面进行工艺的时候,晶圆带器件的一面就会由夹具喷出的氮气(N2)对其进行保护。
该伯努利晶圆夹具采用了盛美的专利技术,可通过控制晶圆和晶圆夹具之间空隙的间距,来控制刻蚀后晶圆边缘的侧向刻蚀宽度,同时满足刻蚀后晶圆边缘无夹具痕迹的要求。该设备可根据需要配置实现高产能,以匹配短工艺时间的应用,产能可达300片以上。也可选配先进的无接触型机械手臂以实现超薄晶圆的传输。
自动槽式清洗设备

Ultra C wb
自动槽式清洗设备Ultra C wb,依托盛美研发的槽式与单片清洗集成设备Ultra C Tahoe的先进槽式技术基础而开发,可以进行多达50片晶圆的批量清洗。自动槽式清洗设备的关键应用为炉管前清洗,RCA清洗,光阻去除,氧化层刻蚀,氮化硅去除,以及晶圆回收工艺中前段FEOL多晶硅/氧化硅层剥离去除,和后段BEOL金属层剥离去除。该设备可针对不同的应用配置不同的化学药液槽,如硫酸,磷酸,氢氟酸(HF),缓冲氧化物刻蚀液(BOE), SC1和SC2等化学药液槽。晶圆依次在化学药液槽中浸泡,经去离子水(DI)冲洗,最后在ATOMO干燥模块中以汽化的异丙醇(IPA)进行干燥,干燥后无水痕。该设备的模块化设计和较小的占地面积,使其可灵活配置。槽式清洗设备Ultra C wb可高效地回收使用化学药水,节能减排。该设备可运用于200毫米或者300毫米的晶圆清洗应用。
刷洗设备
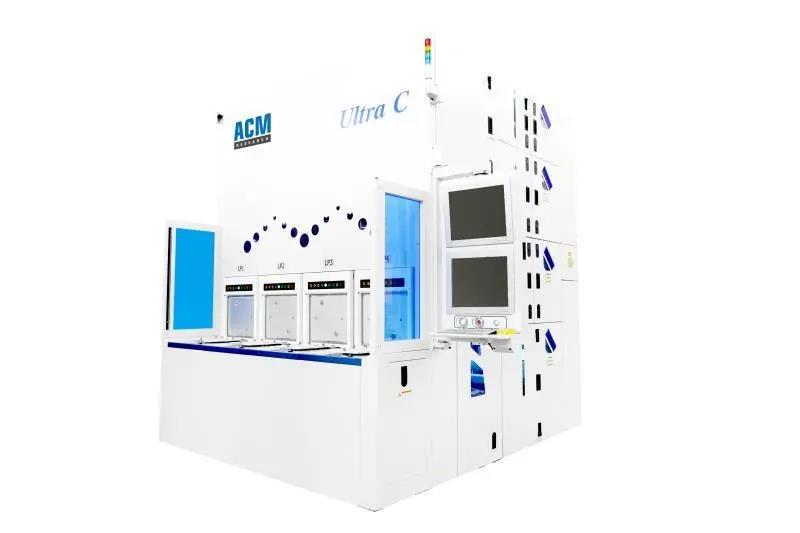
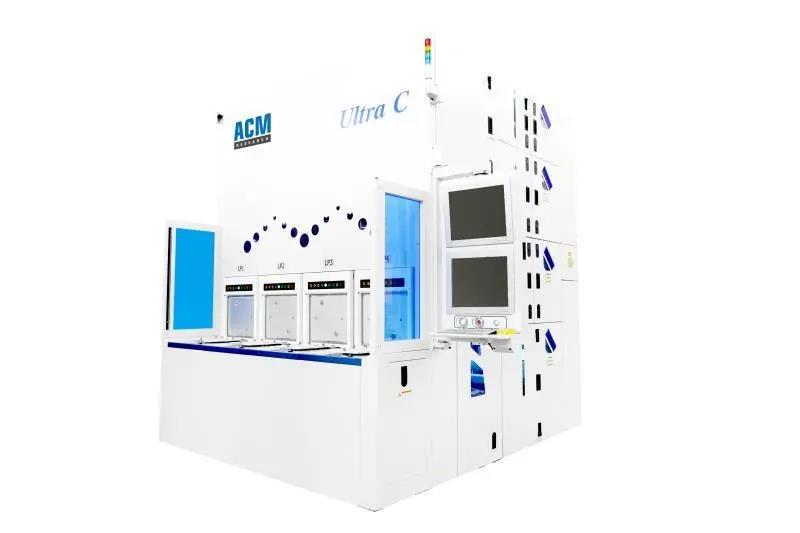
Ultra C s
新型刷洗设备Ultra C s以盛美在晶圆级封装领域(WLP)已验证成功的刷洗技术为基础,延伸应用于集成电路制造领域。其配备的软刷可以采用精准的压力控制以清洗晶圆边缘及背面的颗粒。该设备配有先进的二流体(气体和液体)喷淋清洗技术,还可选配盛美独有的空间交变相位移(SAPS™)兆声波技术以满足客户更高的需求——更强劲的小颗粒去除能力。模块化系统可配置8个腔体,用于集成电路制造领域300毫米的晶圆清洗,其中四个腔体用于正面清洗工艺,四个腔体用于背面清洗工艺。该刷洗设备性价比高,灵活性强、占地面积小、产能高。
关于我们
盛美半导体设备(上海)股份有限公司(ACM Research (Shanghai),Inc.)成立于2005年,是一家注册在上海浦东新区张江高科技园区、具备世界领先技术的半导体设备制造商。盛美拥有国际先进水平的自主知识产权,集研发、设计、制造、销售于一体,是一家专注于单片晶圆清洗设备、电镀铜设备、先进封装湿法设备研发及生产的公司。
责任编辑:sophie
-

- 半导体行业观察
-

- 摩尔芯闻
最新新闻
热门文章 本日 七天 本月
- 1 荣芯半导体:专注成熟工艺
- 2 破除AI落地难题!英特尔全新软硬件平台,助力企业AI创新
- 3 面板行业专题报告之一:OLED的美好时代
- 4 发布新CPU,Imagination进军RISC-V,信心十足






