[原创] 5G手机里的封装学问
2020-06-05
17:07:13
来源: Sophie
目前,芯片的集成度越来越高,制程已经发展到了7nm和5nm,随着芯片制造水平的提升,对封装技术也提出了更高的要求,在这些方面,结合得最好得要数英特尔和台积电了。虽说这两家的业态不同,英特尔是IDM,台积电是Foundry,但它们在发展先进制程工艺的同时,也都在积极研发自家的先进封装技术,目前都处于行业前沿水平。
而看封测OSAT产业的话,全球的焦点都在中国台湾和大陆,日月光,及其收购的矽品,以及大陆的长电科技等,都是全球排名前五的封测企业,也是各自所在地区的龙头。
进入2020年以来,虽然疫情对封测业产生了很大的冲击,但随着先进制程的推进,以及5G等新兴应用的逐步落地,对先进封装技术的发展起到了很大的刺激作用。因此,在疫情未结束的情况下,下半年的封测产业形势还是乐观的。中国台湾资策会产业情报研究所(MIC)表示,今年台湾地区IC封测产值可达新台币4786亿元,较去年4769亿元微幅增长0.35%。
MIC指出,尽管有疫情影响,使得终端消费性需求下滑,不过,5G逐步落地及疫情带来的数字经济商机,仍可支撑今年IC封测产业的表现。
预估日月光投控第2季业绩可望季增6%~9%,其中IC封装测试及材料业绩有望季增5%~6%,较去年同期增长约15%。预估力成第2季较第1季可实现小幅增长,下半年优于上半年,使得全年业绩有望实现同比正增长。
台积电方面,原本就有其先进的封装技术,如InFO、CoWoS等。在此基础上,该公司仍在大力推进更先进的封装技术产线建设。随着台积电芯片制造工艺提升,特别是其5nm产线于今年第二季度量产,3nm产线预计于2021年下半年试产。但是,一些封测大厂的先进封测技术和产业能力却跟不上台积电的发展步伐,现有封测厂难以满足需求,因此,台积电决定再投封测厂。5月27日,中国台湾苗栗县县长徐耀昌在社交媒体上称,台积电将在该县投资3032亿新台币(约为人民币723亿元)建设一个先进封测厂。徐耀昌称,该封测厂的北侧街廓厂区预计于2021年5月完工,2021年中一期厂区可以运转。
Gartner半导体研究副总裁盛陵海表示,台积电此番设新厂主要是出于对先进封装技术的需求,预计新厂将采用晶圆级封装(WLP)技术,即在将整片晶圆进行封装测试之后,再切割成单个芯片。这种技术下,芯片体积可以更小,且性能更佳。WLP是新兴技术,需求一直在增加,所以台积电需要新的工厂。
下面从技术层面看一下市场对先进封装技术的需求,这里主要谈一下5G。
随着手机越来越轻薄,在有限的空间里要塞入更多组件,这就要求芯片的制造技术和封装技术都要更先进才能满足市场需求。特别是在5G领域,要用到MIMO技术,天线数量和射频前端(RFFE)组件(PA、射频开关、收发器等)的数量大增,而这正是先进封装技术大显身手的时候。
目前来看,SIP(系统级封装)技术已经发展到了一个较为成熟的阶段,由于SoC良率提升难度较大。为了满足多芯片互联、低功耗、低成本、小尺寸的需求,SIP是一个不错的选择。SIP从封装的角度出发,将多种功能芯片,如处理器、存储器等集成在一个封装模块内,成本相对于SoC大幅度降低。另外,晶圆制造工艺已经来到7nm时代,后续还会往5nm、3nm挑战,但伴随而来的是工艺难度将会急剧上升,芯片级系统集成的难度越来越大。SIP给芯片集成提供了一个既满足性能需求又能减少尺寸的解决方案。
而为了满足5G的需求,在SIP的基础上,封装技术还在演进。通过更先进的封装技术,可解决产品尺寸过大、耗电及散热等问题,并利用封装方式将天线埋入终端产品,以提升传输速度。
以5G手机为例,应用讲究轻薄短小、传输快速,且整体效能取决于核心的应用处理器(AP)芯片,而随着5G高频波段的启用,负责传输信号的射频前端(RFFE)和天线设计也越来越复杂,需要先进封装技术的支持。
下面就从AP、RFFE和天线这三方面看一下先进封装技术是如何应用的。
要提升AP性能,除了晶圆制程微缩,还要依靠封装技术协助,这里主要是以 POP(Package on package)封装为主,通过POP堆叠DRAM,能有效提升芯片间的传输效率并减小体积。连接方式从传统的打线(wire bonding)、覆晶(Filp chip)等,演进到目前的扇出型(Fan-out)封装。扇出型封装主要是利用RDL布线减少使用载板(substrate)。通过减少载板的使用,间接达到效能提升、改善散热、减小产品尺寸,降低成本的目的。因此,AP多以扇出型POP封装为主。
Omdia分析了三星的5G手机Galaxy S20。该手机的RFFE不仅支持2G / 3G / 4G,还支持sub-6 GHz和毫米波5G。集成的PA是主要RFFE组件,其在很大程度上决定了该5G射频前端的复杂性,要提升集成度,就必须采用更先进的封装技术。
Galaxy S20采用了高通X55调制解调器支持FDD 5G,因为全球运营商可以通过低频段提供必要的信号覆盖范围来大规模部署5G。低频段PAMiD(具有集成双工器的功率放大器模块)对于5G Galaxy S20是必不可少的,这里采用的是Skyworks公司的产品。
下图展示出了支持低频带连接所需的各种5G / 4G RF组件;天线开关、滤波器(SAW)、双工器(用于FDD)和功率放大器(上行链路)。由于采用了先进封装技术,与以前的类似尺寸封装相比,PAMiD现在支持的低频范围更广。此外,中高频段LTE的PAMiD在5G设计中将LTE部分模块化至关重要。由于大多数5G部署都是基于NSA的,因此存在锚定LTE信号至关重要。在三星Galaxy S20中发现了来自Qorvo的中高频段PAMiD。
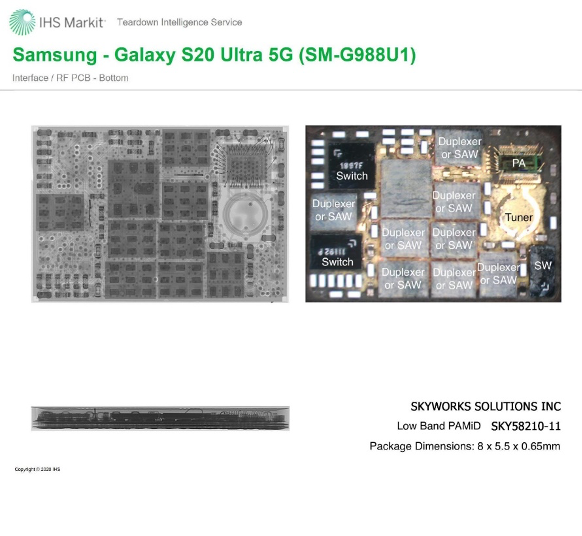
随着5G的成熟,将需要毫米波(24GHz或更高)来继续满足对带宽和容量不断增长的需求。在新一代Samsung Galaxy S20 Ultra 5G智能手机中,除Sub-6GHz的RFFE外,还包括mmWave天线模块。与Sub-6GHz的RFFE相比,mmWave天线模块是RFFE系统集成的终极产品。三星内部的Qualcomm QTM525天线模块包含从相控阵天线到RF收发器的所有组件。高集成度与mmWave衰减的特性有关。因此,要捕获这些非常微弱的信号,必须缩短整个mmWave的RFFE链,以确保连接链路预算内的信号完整性。这些就需要先进的封装技术。
RFFE是5G手机中最复杂的部分,依靠先进的封装技术,手机厂商可以在越来越轻薄的智能手机中添加更多的无线连接器件。
随着高频毫米波频段导入商用,5G信号从1GHz以下延伸至超过 30GHz,其对天线的需求倍增,这使得天线尺寸、路径损耗和信号完整性问题凸显出来。
在天线数量激增、可用面积维持不变的情况下,AiP(Antenna in Package)封装型式就成为了厂商的理想解决方案,AiP 主要采用SiP(System in Package)或PoP结构,将RF芯片置入封装以达到缩小体积、减少传输距离,以降低信号传输时造成耗损之目的。结构上可利用RF芯片的位置将结构区分成两种:一是包含在基板内部的结构,另一种是将RFIC置于基板外侧的结构。
以日月光和力成的方案为例,这两家封测厂都看好28GHz以上毫米波应用的未来商机,它们的AiP技术有望于明年进入量产阶段。
日月光集团研发副总洪志斌表示,该公司的AiP在基板和扇出型技术上均有布局,其中,FO-AiP成本虽高于基板AiP 2-3倍,但预计随着高端芯片需求提升,FO-AiP能大幅缩小系统模组的体积,并让信号更稳、效能更强。
除了可应用于28GHz、39GHz和77GHz等5G高频段的基板制程毫米波AiP技术已步入量产外,预期FO-AiP有望在明年跟进量产。而华为海思、高通的AiP模组、RF前端模组(FEM)将是重要的先进封测订单来源,也是各大封测厂争夺的焦点。
从5G的发展态势来看,将有越来越多的芯片元器件被封装在一起,而且它们的工作频率要比4G和3G提高很多,这些元器件互相之间的干扰也会越来越复杂,需要做更好的屏蔽处理。这些都对先进封装技术提出了更高的要求,同时也充满着商机。
*免责声明:本文由作者原创。文章内容系作者个人观点,半导体行业观察转载仅为了传达一种不同的观点,不代表半导体行业观察对该观点赞同或支持,如果有任何异议,欢迎联系半导体行业观察。
今天是《半导体行业观察》为您分享的第2331期内容,欢迎关注。
『
半导体第一垂直媒体
』
实时 专业 原创 深度
识别二维码
,回复下方关键词,阅读更多
两会|台积电|RISC-V|汽车芯片|AI|EDA|中美|晶圆 | 射频
回复
投稿
,看《如何成为“半导体行业观察”的一员 》
回复
搜索
,还能轻松找到其他你感兴趣的文章!
责任编辑:Sophie