一文看懂TSV技术
来 源:文章由半导体行业观察编译自hardzone,谢谢。
从HBM存储器到3D NAND芯片,硬件市场上有许多芯片是用英文称为TSV构建的,TSV是首字母缩写,意为“通过硅通孔”并翻译为via硅的事实,它们垂直地穿过的芯片和允许在它们之间垂直互通。在本文中,我们将告诉您它们是什么,它们如何工作以及它们的用途。
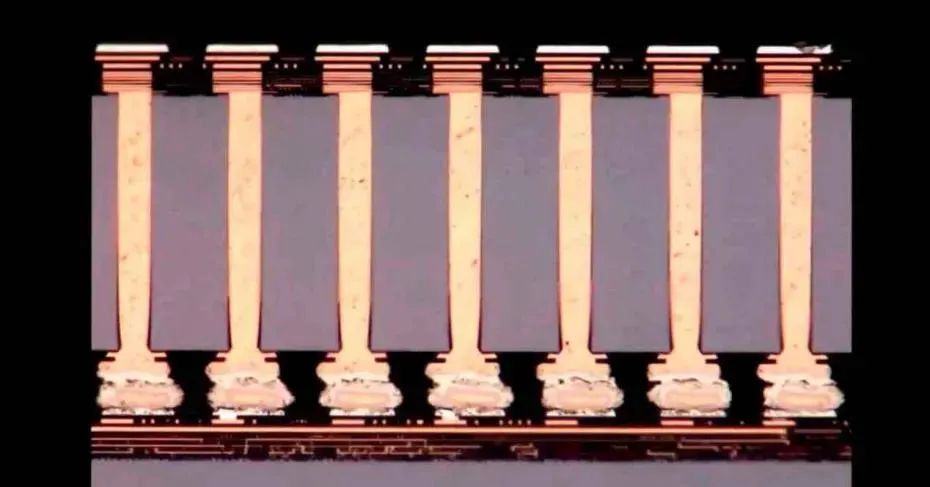
在硬件世界中,经常用与速度有关的术语来谈论它,即是否是内存的带宽,处理器的时钟周期,处理器每秒执行某种类型的计算的次数等等,但是我们很少问自己这些芯片如何相互通信以及这是否重要。
在本文中,我们将讨论一种称为TSV的技术,该技术可用于相互通信的芯片。
什么是硅或TSV通路?
如果我们看大多数主板,可以看到两件事:第一,芯片之间的大多数连接都是水平的,这意味着板上发送芯片间信号的路径是水平通信的。

PCB
然后是CPU的情况,这些CPU放置在我们称为插座的插入器的顶部,并且处理器在这些插入器上垂直连接。

SocketCPU
但是通常,在99%的时间中,我们观察到通常没有相互垂直连接的芯片,尽管事实上芯片和处理器的设计朝着这个方向发展,并且市场上已经有这种类型的示例。但是,如何使两个或更多芯片垂直互连?

TSV
好吧,正是通过所谓的硅通道来完成的,硅通道垂直穿过组成堆栈的同一芯片的不同芯片或不同层,这就是为什么它们被称为“通过”硅通道,因为它们实际上是通过的。
使用TSV的应用和优势
TSV的应用之一是,它允许将由不同部分组成的复杂处理器分离在几个不同的芯片上,并具有以下附加优点:垂直连接允许更多数量的连接,这有助于实现更大的带宽,而无需额外的带宽。很高的时钟频率会增加数据传输期间的功耗。
例如,在将来,我们将看到CPU和GPU的最后一级缓存将不在芯片上,它们具有相同的带宽,但存储容量却是原来的几倍,这将大大提高性能。我们也有使用FSV来通信Lakefield SoC的两个部分的Intel Foveros示例,即带有系统I / O所在的基本芯片的计算芯片。
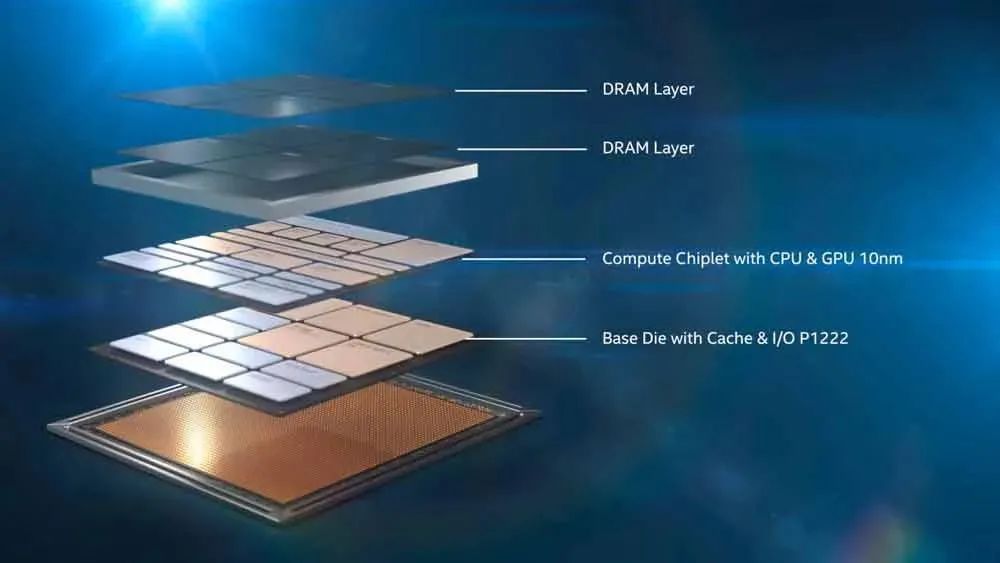
LakefieldFoveros
将处理器划分为不同部分的原因是,随着芯片的变大,电路中错误的可能性越来越大,因此没有故障的优质芯片的数量会增加。他们可以使用的更少,而那些做得好的人必须支付失败者的费用;这意味着从理论上减小芯片的尺寸会降低总体成本,尽管稍后我们将看到情况并非完全如此。
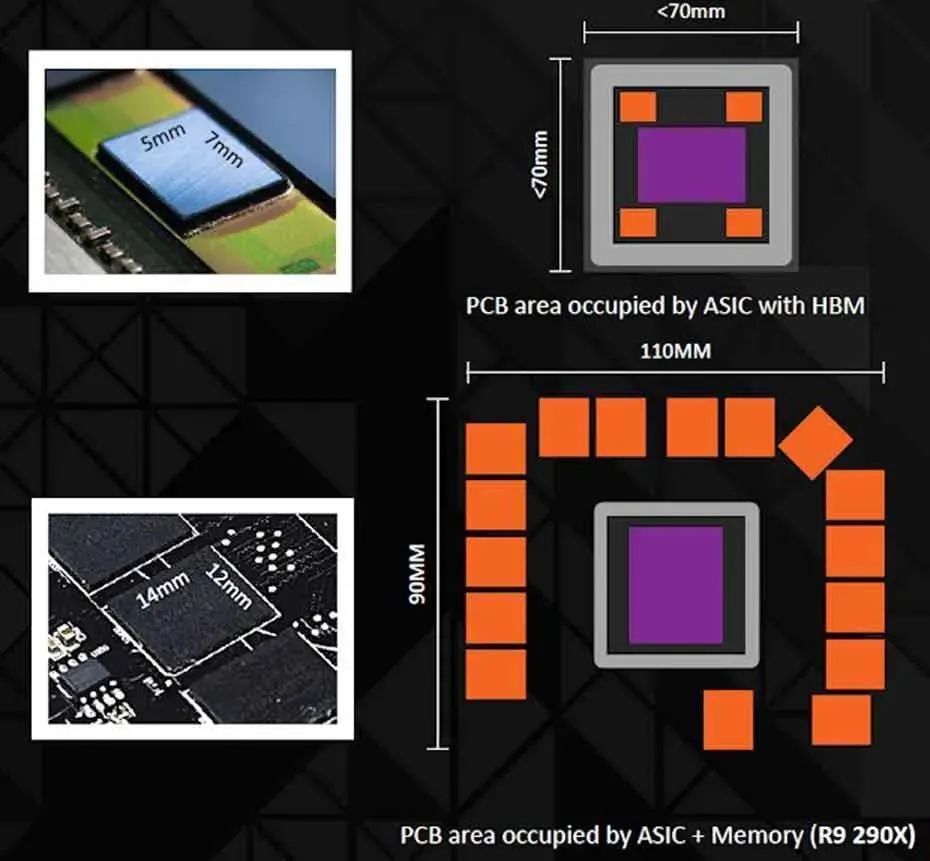
HBM-vs-GDDR
第二个应用程序与占用的空间有关;能够垂直堆叠多个芯片的事实大大减少了它们占用的面积,因为它们不会散布在板上,其中最著名的示例是将HBM内存用作某些图形处理器的VRAM,但是我们还有其他示例,例如三星的V-NAND存储器,将多个NAND闪存芯片彼此堆叠。
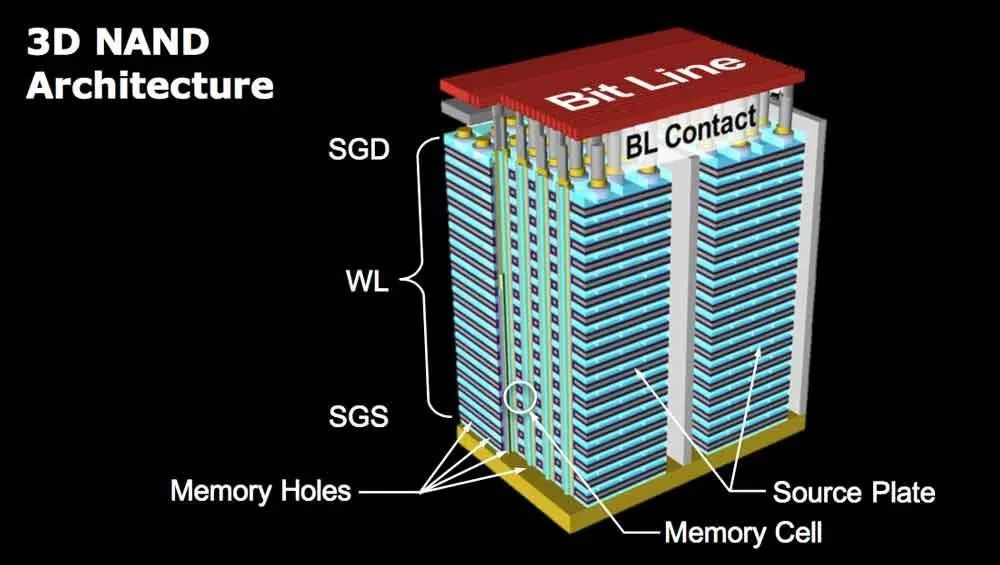
3DNAND
其他鲜为人知的选择是逻辑和内存的组合,其中内存位于处理器的顶部,最著名的示例是宽I / O内存,这是几年前出现在智能手机中的一种内存,包括SoC顶部的存储器通过硅互连。
为什么采用硅途径如此缓慢?
TSV存在一些固有的问题,这意味着尽管数十年来在纸上是一种非常有前途的技术,但它并没有完全普及,仍然是一种为很小的市场生产芯片但利润率很高的方法。
他们的第一个问题是,要实施一项极其昂贵的技术,需要对许多公司的生产线进行深刻的变革,这些公司多年来一直在生产没有TSV的芯片,并且对于许多应用而言,传统的制造工艺已被证明是足够好的。
第二个问题是,如果组成垂直结构的一部分完全失效,则必须丢弃整个结构,这会使通过TSV互连的系统制造起来更加昂贵。HBM内存的示例在这方面意义重大,其成本如此之高,以致无法用作消费市场的内存。
第三个问题是热阻塞,芯片在某些温度条件下达到其时钟速度,如果附近有另一个也会发热的芯片会受到影响。例如,我们可能有两个处理器,每个处理器分别达到1 GHz,但由于温度问题,垂直放置在TSV结构中的每个处理器只能达到0.8 GHz。
这是当今工程师最关心的第三点,并且正在开发冷却机制,以使构成堆栈的芯片保持尽可能低的温度,以避免热淹没问题。
今天是《半导体行业观察》为您分享的第2494期内容,欢迎关注。
推荐阅读
★ 中国CIS的崛起
半导体行业观察

『 半导体第一垂直媒体 』
实时 专业 原创 深度
识别二维码 ,回复下方关键词,阅读更多
存储|晶圆 |光刻 |FPGA|并购|Marvell|华为|功率半导体
回复
投稿
,看《如何成为“半导体行业观察”的一员 》
回复 搜索 ,还能轻松找到其他你感兴趣的文章!
-

- 半导体行业观察
-

- 摩尔芯闻