苹果芯片所用的这项技术,潜力巨大!
2023-03-06
19:01:25
来源: 杜芹
点击
进入后摩尔时代,越来越考验各家芯片厂商的集大成能力,芯片要继续朝着小型化、多引脚和高集成的方向持续发展,除了常规的工艺微缩,各种先进封装技术已然不可或缺。作为后摩尔时代芯片性能提升最佳途径,以倒装芯片(Flip-chip)等为代表的先进封装技术平台已成为中高性能产品封装优选方案,而在倒装芯片中又以FCBGA技术为主流。
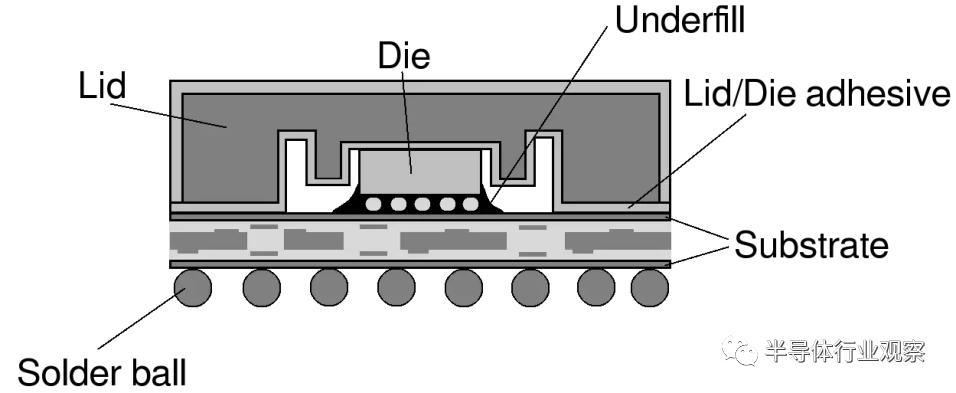


苹果是FCBGA封装技术的忠实采用者,苹果最早在自家的处理器中应用FCBGA封装技术,是在2006年的A5处理器上,该处理器被用于第一代iPad和iPhone 4S。自那时以来,苹果公司一直在使用FCBGA封装技术,并不断改进和提高其性能,直至最近推出的PC处理器M系列。近日苹果供应商LG Innotek开始进军FCBGA基板市场,业界推测或将为苹果M系列芯片提供FCBGA基板,这也从侧面反映出FCBGA的市场需求。苹果所用的这项封装技术,正迎来蓬勃发展。
FCBGA技术在多领域全面开花
FCBGA(Flip Chip Ball Grid Array,意为“倒装芯片球栅阵列封装”)是一种封装技术,这种封装方式将芯片倒置并连接到封装基板上,然后使用球形焊点将封装固定到基板上。FCBGA最早出现于1990年代初。1997年,Intel公司将FCBGA封装技术首次应用于处理器,这是FCBGA技术历史上的一个重要里程碑。
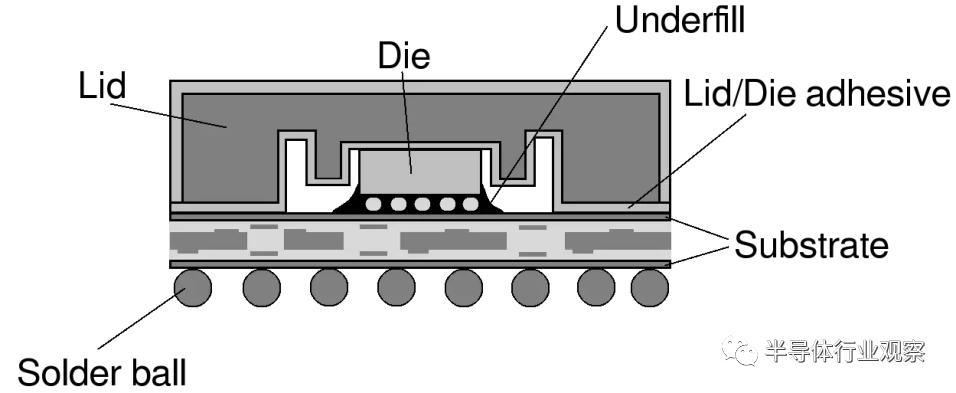
典型的倒装芯片BGA封装横截面视图(图源:维基百科)
1999年英特尔推出了第一款使用FCBGA封装技术的芯片,即Pentium III 500处理器。在此之前,处理器的封装方式主要为多芯片模块(MCM),MCM将多个芯片组件集成在一个封装中,由于连接线路复杂,MCM封装方式存在信号互干扰、热管理不佳等问题。相比之下,FCBGA封装技术将芯片翻转过来,将芯片背面的金属引脚(bump)与印在封装上的金属球(ball)连接起来。这种封装方式可以实现更高的芯片密度和更小的封装体积,从而大大提高了集成度和系统性能。Pentium III 500处理器的推出标志着FCBGA技术的商业化应用,该技术成为了当时电子行业的热点话题之一。
随着FCBGA技术逐渐得到完善,制造商不断提高其可靠性,尤其是在焊点连接、微调整和外壳包装方面的技术。FCBGA封装技术的优点主要包括:
更高的密度:因为FCBGA封装技术可以在同样的封装面积内安装更多的芯片引脚,从而实现更高的集成度和更小的封装尺寸。
更好的散热性能:FCBGA能允许芯片直接连接到散热器或散热片上,从而提高了热量传递的效率。
更高的可靠性和电性能:因为它可以减少芯片与基板之间的电阻和电容等因素,从而提高信号传输的稳定性和可靠性,也可以提高信号传输的速度和准确性。
总的来说,FCBGA封装技术具有高集成度、小尺寸、高性能、低功耗等优势,FCBGA适用于多种种类的芯片,其常用于CPU、微控制器和GPU等高性能芯片,还适用于网络芯片、通信芯片、存储芯片、数字信号处理器(DSP)、传感器、音频处理器等等。FCBGA目前是移动设备中的理想封装技术,被广泛应用于智能手机、平板电脑和其他移动设备中。
正是这些优势使得FCBGA成为了现代半导体封装的主流技术之一,许多大型半导体公司和电子产品制造商如英特尔、AMD、英伟达、高通、苹果、三星等都在使用FCBGA技术。
作为FCBGA技术的开拓者之一,FCBGA是英特尔公司常用的一种封装技术,如今英特尔的酷睿和至强系列处理器、芯片组、内存芯片以及无线网卡这些电子组件等均采用了不同型号的FCBGA封装技术,如酷睿i9-11900K处理器采用了FCBGA1700封装、英特尔Z590芯片组采用了FCBGA1492封装、Optane内存模块采用了FCBGA1440封装、英特尔AX210无线网卡采用了FCBGA946封装。AMD的Athlon XP处理器使用了FCBGA封装技术。
值得一提的是,FCBGA技术还被用于3D封装,FCBGA技术的高密度和高可靠性的特点使其非常适合于3D封装中的芯片封装。在3D封装中,顶层芯片和底层芯片之间需要通过微细的电气连接进行通信,这种连接称为TSV(Through Silicon Via)。而FCBGA技术则可以在TSV的两侧分别封装顶层芯片和底层芯片,从而实现它们之间的电气连接。
在Yole对先进封装技术的数据统计中,FCBGA是最赚钱的细分封装市场之一,然后是2.5D/3D封装、FCCSP等等。作为一种重要的芯片封装技术,FCBGA随着移动设备、智能家居、物联网等技术的快速发展,其市场需求也在不断增长。根据市场研究机构的数据显示,全球FCBGA封装技术市场在未来几年内将继续保持快速增长,预计到2026年市场规模将达到200亿美元以上。越来越多的企业和研发机构投入到FCBGA封装技术的研究和开发中,不断推动着FCBGA封装技术的革新和升级。

FCBGA市场主要有哪些玩家?
FCBGA技术的发展是多个厂商的协同努力的结果,这些厂商在封装技术、连接技术和热管理技术等方面都做出了贡献。接下来,我们主要来谈谈FCBGA市场中封装技术和基板这两大领域的玩家。
在FCBGA封装领域,有像英特尔、英飞凌、美光、恩智浦等IDM厂商在该领域进行了大量的研究和开发工作之外,还有如日月光、长电、Amkor等第三方技术提供商。其中日月光开发了多种FCBGA封装技术,包括CSP(Chip Scale Package)和FPBGA(Fine-Pitch Ball Grid Array)等;Amkor也有包括FCBGA和TFBGA(Thin Fine-Pitch Ball Grid Array)等多种FCBGA封装技术。
而近几年国内一众CPU、GPU和其他高性能芯片领域厂商的崛起,加大了对FCBGA封装技术的需求。因应市场需求,国内也出现了一些技术能力强、业务快速增长的供应商,如摩尔精英,据悉,摩尔精英的无锡SiP先进封测中心能提供DPU、HPC、CPU、GPU、高端服务器、高性能ASSP、FPGA等产品的Flip-Chip封装完整解决方案,包括封装设计、仿真、工程批和量产,其FCBGA产能可达1KK每月。除了FCBGA之外,摩尔精英还可提供SiP、QFN、WB、FCCSP等多种封装类型,其SiP团队拥有超过15年的封装技术和工程经验,完成过国际大厂客户的SiP开发工作,这也为中小芯片公司带来了更多的选择。
基板也是FCBGA封装技术的一个重要支撑,FCBGA常用的基板材料包括印制电路板(PCB)、硅基板、铜基板,至于具体使用哪种材料取决于应用的需求和成本考虑。

FCBGA封装用基板(图源:Toppan Printing)
在FCBGA封装中,常用的载板材料是ABF(Advanced Build-up Film)载板,它是一种多层PCB。对于大多数应用来说,ABF载板是一种性价比很高的选择,能够满足绝大部分的封装需求。ABF载板的特点是它非常薄、轻和柔软,具有良好的热传导性能和低介电损耗,这使得它成为FCBGA封装技术的理想载板材料之一。在整个封装过程中,ABF载板的质量和设计对于确保FCBGA封装的质量和可靠性至关重要。
而上述的另外两种则相对较昂贵,硅基板可以提供高度的电气性能和较低的信号延迟,但相对较昂贵;铜基板是一种特殊的PCB,它使用铜箔代替标准的导电材料,铜基板可以提供更好的热传导性能,适用于需要高功率处理的应用。
全球主要的基板供应商包括日本地区的Toppan Printing、Ibiden,台湾地区的Unimicro、Nanya,韩国的LG Innotek,及国内地区的AT&S、苏州群策等。随着5G和AI应用提供动力的高性能芯片的需求不断增长,全球领先企业正在积极扩大产能。
例如,2022年三星旗下子公司三星电机已经花费了大约2万亿韩元用于FCBGA 的设施扩建。三星电机估计未来五年FCBGA基板市场将以每年14%的速度增长,到2026年将达到170亿美元。“半导体封装基板市场规模小于芯片代工业务,但其增长潜力要大得多 ”三星电机封装支持团队负责人Ahn Jung-hoon说。
韩国的LG Innotek于2022年2月22日宣布,公司决定投资4130亿韩元用于“倒装芯片球栅阵列 (FCBGA)”生产线,这是LG Innotek首次投资FC-BGA业务。LG Innotek此前主要在5G 毫米波封装天线 (AiP) 和射频系统级封装 (RF-SiP) 引领着通信封装基板市场。该公司通过多年的AiP和 SiP产品开发经验获得了基板技术,并打算将这些技术也用于 FCBGA业务。
除了商业类厂商之外,还有一大批的科学家、工程师、技术专家等,他们的不断努力和创新精神,才使得FCBGA技术不断发展和完善,将FCBGA封装技术从最初的概念变成了如今在各种电子产品中广泛应用的技术之一。
结语
综上所述,FCBGA技术在过去几十年中经历了快速发展,已经成为了处理器、存储器、图形处理器等核心电子元件的主要封装方式之一。FCBGA技术在未来还将面临更高的性能和应用需求,特别是在5G通信、人工智能、虚拟现实等领域的发展中,FCBGA封装技术正在扮演着越来越重要的角色。
责任编辑:sophie
-

- 半导体行业观察
-

- 摩尔芯闻
最新新闻
热门文章 本日 七天 本月
- 1 澜起科技率先试产DDR5时钟驱动器(CKD)芯片
- 2 UWB"上车"加速,国产芯片大有可为
- 3 BEYOND Expo 2024国际芯片及应用产品展将于5月23日在澳门拉开帷幕
- 4 见格局、见匠心,紫光国微开启第二增长曲线