封装设备的黑马,下注面板级封装
2023-07-07
18:52:40
来源: 互联网
点击
近年来,在各种地缘政治的影响下,大家对半导体产业链有了更广泛的认识。特别是在光刻机等前道设备方面,大部分从业者都知道了国内厂商在这些环节的薄弱。但其实在少被提及后段的封装设备市场,国内厂商也差距不小。
华封科技有限公司联合创始人兼董事长王宏波先生在2022年六月的一场分享中就曾经表示:“2019年,封装设备国产化率只有1.8%到2.0%,近两年可能有所提升,但仍是个位数水平。”为此王宏波先生认为,在国产化设备需求的现状下,这必将给拥有技术能力的厂商带来巨大的成长空间。
在过去多年通过推出多款产品获得了一系列头部客户认可之后,华封科技在日前举办的Semicon China上发布了公司新一代的面板级封装设备,引领公司跃上新台阶。
以先进封装切入,高举高打
王宏波先生表示,从成立开始,华封科技就锚定了先进封装领域,这出于两方面的考虑:
一方面,华封拥有技术过硬的团队。据介绍,华封科技的创始团队成员主要来自ESEC、K&S、BESI和ASE等企业,他们拥有数十年的年半导体行业从业经历,尤其是在贴片机、打线机、分拣机、塑封机等封装设备领域,他们更是拥有深厚的软硬件开发经验。
另一方面,华封从一开始就选择与优质客户的合作,利用设备与客户打造了极强的粘性,这就让后来者很难与之竞争,建立起更高的壁垒。
基于这两点,华封科技将公司的产品定位为“平台加模块”的模式,聚焦于使用统一平台固定量产需求的核心,保障整个设备的精度、速度和稳定性。然后再通过不同模块去适配不同的先进封装工艺以及不同的客户对于工艺的定制化需求。
到2016年就推出了第一台高精度的Flip Chip倒装产品2060P,并通过了PTI的技术验证。进入2017年,华封科技研究成功了晶圆级封装产品,正是进入了日月光的技术验证。在随后的一年,公司更是完成了TSMC和TFME等国际头部客户的技术验证,进一步拓宽了公司产品的应用范围。
36Kr在早前的一篇报道中也讲到,历经多年的发展,华封科技在先进封装核心技术——高精度、高速度、高稳定性方面有了深厚的积累,尤其在高精度取放方面,公司更是有着独到的见解。
报道指出,华封科技拥有全球独家拿取裸晶工艺设计专利,并且在机台设计上增加了buffer系统,可以从buffer上直接拿取裸晶,无需从wafer上直接拿取,增强拿取动作的稳定性和精准性;同时,基于全自研的电控和机械系统,华封科技开发的产品能实现超高精度和运动控制,抓取颗粒较小的晶粒;此外,华封还自研了动态补充核心算法,专门解决机台长时间使用后的微小变形走位问题,对机台做实时动态补偿,保证设备精度。
在这样的技术支持下,华封科技已经针对半导体后道工序提供全新一代半导体装嵌及封装设备,如倒装贴片机(Flip-Chip Bonder)、晶圆级贴片机(Chip-on-Wafer Bonder),POP封装机(Package-on-Package Bonder),层叠半贴片机(Stack Die Bonder),面板级贴片机(Panel-Level Die Bonder),多晶片贴片机(Multi-Chip Die Bonder)等。
具体而言,华封科技共规划了A系列(Andromeda 仙女座)、L系列(Leo 狮子座)、R系列(Reticulum 网罟座)、M系列(Monocerotis 麒麟座)、V系列(Venus 金星)和E系列(Eridani 波江座)共六大系列产品,以支持多种场景下的需求。
近日发布的L6,更是公司L系列首款代表性产品,这将为国内的企业在面板级封装(PLP:Panel Level Package)市场提供强力的支持。
发力面板级封装
华封科技早前表示,公司产品对先进封装贴片工艺实现了全面覆盖,包括FOWLP(Face Up/Down)、POP、MCM、EMCP、Stack Die、SIP、2.5D/3D、FCCSP、FCBGA等。这让公司能够满足了大部分先进封装的需求。
但公司并没有止步于此,借助刚发布的狮子座系列新品AvantGo L6,华封科技往着备受看好的面板级封装技术进军。
相较于传统封装技术,面板级封装将多个芯片器件组装在一个基板上,然后进行封装,这让其能够拥有更高的集成度,从而实现更高的集成度和更小的尺寸;又因为其基板内的互联线路长度较短,这也让其拥有更低的功耗;由于采用更便宜的材料,面板级封装的成本也较低。
得益于上述领先优势,面板级封装能看作是一个能用于制造高性能、高密度电子产品的技术。但在王宏波看来,这并不能完全概括面板级封装的特点。因为他认为这个封装技术并不是对FOWLP(Fan out Wafer Level Package)等先进封装技术的替代,而更像是一个对QFN和BGA等传统封装进行颠覆的新技术。
“根据预判,在采用我们面板级封装设备生产的产品,可以获得比传统封装低50%的成本优势”,王宏波接着说。
据介绍,AvantGo L6拥有超高的UPH,前后级同时工作,最大支持700mmx750mm载盘冷、热焊接;同时,该设备还拥有高精度、双动染多键合头,支持芯片正装、倒装自由切换。其中,对芯片正反贴装的支持最大能够达到100mmx100mm;其多中芯片进料方式、自动吸嘴更换以及独立双晶圆台的设计,使其能够同时便利地处理多种芯片设计;机械手臂的自动上下料,也增加了设备的可靠性和效率。此外,华封科技AvantGo L6能够支持最小Bonding force 的30g力,并可实时反馈,这让其在实际应用中优势尽显。
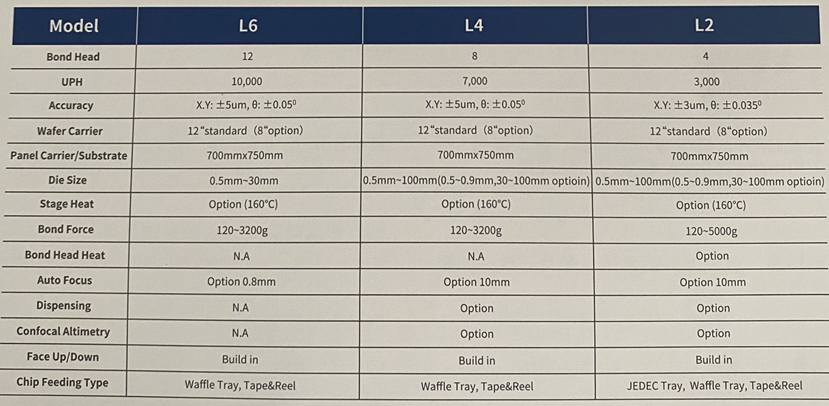
总而言之,如上图所示,华封科技的最新面板级封装设备无论是在精度、速度、占地空间、机台间互联、晶圆尺寸、基板尺寸、芯片尺寸或者是芯片厚度方面,都有着无与伦比的优势。展望未来,华封科技希望能够成为国产封装设备的重要角色,助力中国半导体乃至全球半导体产业穿越后摩尔时代的瓶颈。
于笔者而言,也希望华封科技能够补上国内在封测设备领域的短板,从无论是传统还是先进技术上,让中国厂商在国际市场上有一席之地。
华封科技有限公司联合创始人兼董事长王宏波先生在2022年六月的一场分享中就曾经表示:“2019年,封装设备国产化率只有1.8%到2.0%,近两年可能有所提升,但仍是个位数水平。”为此王宏波先生认为,在国产化设备需求的现状下,这必将给拥有技术能力的厂商带来巨大的成长空间。
在过去多年通过推出多款产品获得了一系列头部客户认可之后,华封科技在日前举办的Semicon China上发布了公司新一代的面板级封装设备,引领公司跃上新台阶。
以先进封装切入,高举高打
王宏波先生表示,从成立开始,华封科技就锚定了先进封装领域,这出于两方面的考虑:
一方面,华封拥有技术过硬的团队。据介绍,华封科技的创始团队成员主要来自ESEC、K&S、BESI和ASE等企业,他们拥有数十年的年半导体行业从业经历,尤其是在贴片机、打线机、分拣机、塑封机等封装设备领域,他们更是拥有深厚的软硬件开发经验。
另一方面,华封从一开始就选择与优质客户的合作,利用设备与客户打造了极强的粘性,这就让后来者很难与之竞争,建立起更高的壁垒。
基于这两点,华封科技将公司的产品定位为“平台加模块”的模式,聚焦于使用统一平台固定量产需求的核心,保障整个设备的精度、速度和稳定性。然后再通过不同模块去适配不同的先进封装工艺以及不同的客户对于工艺的定制化需求。
到2016年就推出了第一台高精度的Flip Chip倒装产品2060P,并通过了PTI的技术验证。进入2017年,华封科技研究成功了晶圆级封装产品,正是进入了日月光的技术验证。在随后的一年,公司更是完成了TSMC和TFME等国际头部客户的技术验证,进一步拓宽了公司产品的应用范围。
36Kr在早前的一篇报道中也讲到,历经多年的发展,华封科技在先进封装核心技术——高精度、高速度、高稳定性方面有了深厚的积累,尤其在高精度取放方面,公司更是有着独到的见解。
报道指出,华封科技拥有全球独家拿取裸晶工艺设计专利,并且在机台设计上增加了buffer系统,可以从buffer上直接拿取裸晶,无需从wafer上直接拿取,增强拿取动作的稳定性和精准性;同时,基于全自研的电控和机械系统,华封科技开发的产品能实现超高精度和运动控制,抓取颗粒较小的晶粒;此外,华封还自研了动态补充核心算法,专门解决机台长时间使用后的微小变形走位问题,对机台做实时动态补偿,保证设备精度。
在这样的技术支持下,华封科技已经针对半导体后道工序提供全新一代半导体装嵌及封装设备,如倒装贴片机(Flip-Chip Bonder)、晶圆级贴片机(Chip-on-Wafer Bonder),POP封装机(Package-on-Package Bonder),层叠半贴片机(Stack Die Bonder),面板级贴片机(Panel-Level Die Bonder),多晶片贴片机(Multi-Chip Die Bonder)等。
具体而言,华封科技共规划了A系列(Andromeda 仙女座)、L系列(Leo 狮子座)、R系列(Reticulum 网罟座)、M系列(Monocerotis 麒麟座)、V系列(Venus 金星)和E系列(Eridani 波江座)共六大系列产品,以支持多种场景下的需求。
近日发布的L6,更是公司L系列首款代表性产品,这将为国内的企业在面板级封装(PLP:Panel Level Package)市场提供强力的支持。
发力面板级封装
华封科技早前表示,公司产品对先进封装贴片工艺实现了全面覆盖,包括FOWLP(Face Up/Down)、POP、MCM、EMCP、Stack Die、SIP、2.5D/3D、FCCSP、FCBGA等。这让公司能够满足了大部分先进封装的需求。
但公司并没有止步于此,借助刚发布的狮子座系列新品AvantGo L6,华封科技往着备受看好的面板级封装技术进军。
相较于传统封装技术,面板级封装将多个芯片器件组装在一个基板上,然后进行封装,这让其能够拥有更高的集成度,从而实现更高的集成度和更小的尺寸;又因为其基板内的互联线路长度较短,这也让其拥有更低的功耗;由于采用更便宜的材料,面板级封装的成本也较低。
得益于上述领先优势,面板级封装能看作是一个能用于制造高性能、高密度电子产品的技术。但在王宏波看来,这并不能完全概括面板级封装的特点。因为他认为这个封装技术并不是对FOWLP(Fan out Wafer Level Package)等先进封装技术的替代,而更像是一个对QFN和BGA等传统封装进行颠覆的新技术。
“根据预判,在采用我们面板级封装设备生产的产品,可以获得比传统封装低50%的成本优势”,王宏波接着说。
据介绍,AvantGo L6拥有超高的UPH,前后级同时工作,最大支持700mmx750mm载盘冷、热焊接;同时,该设备还拥有高精度、双动染多键合头,支持芯片正装、倒装自由切换。其中,对芯片正反贴装的支持最大能够达到100mmx100mm;其多中芯片进料方式、自动吸嘴更换以及独立双晶圆台的设计,使其能够同时便利地处理多种芯片设计;机械手臂的自动上下料,也增加了设备的可靠性和效率。此外,华封科技AvantGo L6能够支持最小Bonding force 的30g力,并可实时反馈,这让其在实际应用中优势尽显。
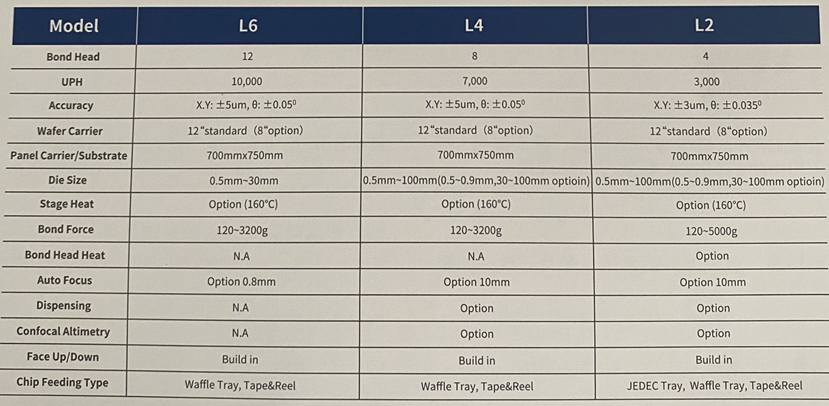
总而言之,如上图所示,华封科技的最新面板级封装设备无论是在精度、速度、占地空间、机台间互联、晶圆尺寸、基板尺寸、芯片尺寸或者是芯片厚度方面,都有着无与伦比的优势。展望未来,华封科技希望能够成为国产封装设备的重要角色,助力中国半导体乃至全球半导体产业穿越后摩尔时代的瓶颈。
于笔者而言,也希望华封科技能够补上国内在封测设备领域的短板,从无论是传统还是先进技术上,让中国厂商在国际市场上有一席之地。
责任编辑:sophie
相关文章
-

- 半导体行业观察
-

- 摩尔芯闻
最新新闻
热门文章 本日 七天 本月
- 1 当我拿出 4 卡 GPU 测试 Ansys 流体仿真,阁下该如何应对?
- 2 英飞凌2024汽车创新峰会:揭秘全球汽车芯片No.1供应商的创新与布局
- 3 收购GaN Systems后,英飞凌氮化镓迎来新突破
- 4 ADI携4大产品线亮相上海慕展,引领智能边缘行业新升级
- 5 迈来芯亮相上海慕展,解析技术创新布局与中国本土化战略