国产半导体封测设备,迎来新突破!
2024-04-01
14:23:49
来源: 李晨光
点击
近年来,随着芯片制程工艺的持续演进,导致晶体管物理尺寸缩小濒临极限带来的量子隧穿效应、原子级加工工艺等问题愈发凸显,“摩尔定律”迭代进度放缓。
“后摩尔时代”,在芯片前道工艺技术节点受限的情况下,先进封装技术通过优化芯片间互连,在系统层面实现算力、功耗和集成度等方面的提升,成为突破摩尔定律的关键技术方向,备受行业瞩目。
根据市场调研机构Yole预期,2021~2027年先进封装行业复合增速将达到9.8%,至2027年先进封装市场规模将达到591亿美元。
先进封装市场迎来快速发展。其中,作为产业链上游环节的设备市场,随着下游应用场景的不断丰富,对封测环节制程技术的要求不断提高,封测设备逐渐步入产业链核心地带,成为延伸摩尔定律的主要支柱之一。
在此趋势下,后道设备厂商迎来了新的市场机遇和发展空间。
在刚举办的2024年SEMICON China展会上,达仕科技携Laser激光切割设备、TCB热压合覆晶键合机等亮点设备隆重亮相,达仕科技董事长苏文华先生向半导体行业观察分享了新设备的特色优势,以及达仕科技在半导体封测设备领域的创新布局与市场规划。
 达仕科技SEMICON China 2024展位
达仕科技SEMICON China 2024展位达仕科技携优势产品亮相SEMICON China 2024
在展会现场,达仕科技带来了Laser激光切割设备。据董事长苏文华先生介绍,达仕科技Laser激光切割设备,主要包含无缝切割、激光隐形切割和激光开槽三类设备。
 达仕科技董事长苏文华先生接受采访
达仕科技董事长苏文华先生接受采访该设备拥有多重优势:
· 无缝切割提高晶圆利用率:激光无缝切割采用达仕专利的光源取代传统刀片切割,实现无耗材无水及更高效率和精度的生产切割道几乎为零的产品,对于不同厚度晶圆,切割速度约是传统刀切的5倍以上。大幅降低切割道尺寸,切割道较窄wafer的利用率更高,提高同尺寸wafer的芯片产出;
· 激光隐形切割设备:采用红外光源,SLM多焦点技术和RTF的实时焦点跟随技术,可完成硅、碳化硅、光学玻璃等材料产品切割,可大幅提高同类单焦点设备速率的1.5倍以上;
· 激光开槽效率高:采用皮秒光源和SLM多焦点技术,减少热影响区,可完成Low-k晶圆、LCD driver晶圆、碳化硅、氮化镓等产品开槽。
 达仕科技Laser激光切割设备
达仕科技Laser激光切割设备当前,在集成电路电子元件向精密微型与高度集成方向发展中,晶圆厚度越来越薄、晶圆尺寸越来越大、芯片之间的线宽、切割槽以及芯片尺寸逐渐微缩,对划切技术提出更加苛刻的要求,高稳定性、高精度、高效率与智能化成为业内需求的新标杆。
对此,达仕科技的Laser激光切割设备凭借诸多优势,能完美满足行业日益严苛的需求。
董事长苏文华先生表示,达仕科技在激光切割领域的研发投入已经有十几年时间。分选机的研发布局早,早在2011年,就参与2个国家“十一五”规划02专项任务研发成功,并后续参与2个国家“十二五”规划02专项研发任务。
2013年,达仕科技又与新加坡国家实验室进行合作,启动激光划片技术研发项目;2020年无缝隙激光划片技术研发成功,过多次技术迭代和风险测试,拥有深入的技术和经验积累。
在一系列的前期布局和研发投入下,达仕科技不断取得新成果。整体设备与技术能很好的满足市场和客户需求,除了在中国大陆市场应用之外,已经拓展至欧美、日韩、中国台湾、新加坡、泰国、马来西亚等全球性服务,依据客户需求提供客制化服务。据悉,达仕科技转塔分选机设备已是长电科技等封测大厂最为广泛采购的设备之一。
另一边,TCB热压合覆晶键合机,是达仕科技本次展会的另一大亮点。
TCB(Thermo-Compression Bonding)是一种高端的芯片封装技术,其核心是通过热压键合技术将芯片与基板固定在一起,从而实现高密度的芯片封装。
据了解,TCB热压键合需要进行严格的工艺控制,包括焊接温度、压力、时间等,需要对工艺进行严格控制和监测,以确保焊点的质量和可靠性,同时需要对工艺参数进行优化和改进,以提高键合的质量和效率。
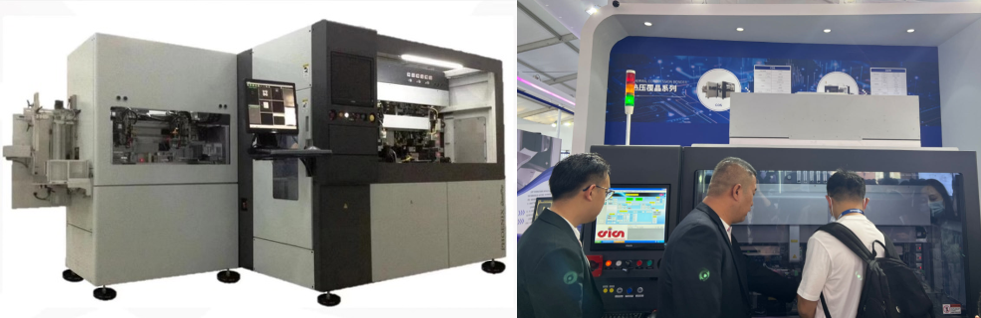 达仕科技TCB热压合覆晶键合机
达仕科技TCB热压合覆晶键合机对此,达仕科技深谙行业需求,且拥有丰富的经验积累和技术创新实力。董事长苏文华先生向笔者表示,达仕科技热压键合TCB设备是国内首家量产的TCB设备,拥有COS和COW两种量产机型。该设备采用模块化设计理念,可以兼容实现FC、CUF-TCB、NCP-TCB、NCF-TCB、COWOS等不同热压键合工艺。其核心指标达到:多键合头,精度:±1.5um、Chip size:0.5x0.5-110x110(mm)等。
能看到,作为封装设备领域的佼佼者,达仕科技持续走在技术前沿,不断推出高精度的键合设备以满足市场的日益增长需求。
TCB热压键合设备的推出,可以视为达仕科技对市场的深度洞察与前沿技术的完美结合。它不仅进一步加强了达仕科技在高精密键合机领域的领先地位,也为电子制造行业提供了更为精准、稳定的解决方案。
依托于此项技术,达仕科技将继续为电子组装行业和半导体行业的融合发展贡献力量,并助力全球客户提升生产效率与产品品质。
达仕科技之所以能够在封装设备领域紧跟行业需求,保持领先性。董事长苏文华先生表示,这得益于时间和经验的积累,以及“两岸三地”的战略布局构思。当前,达仕科技在新加坡、中国大陆和中国台湾都设有研发中心。在新加坡,达仕科技和新加坡国家实验室合作进行研发,深入践行“产学研”战略。
达仕科技结合三地的团队、技术、市场需求和产业链,综合海内外市场特点和经验,更进一步的完善公司平台级的产线,为业界提供最新的产品技术和解决方案,走在行业前列。
除了上述两款设备之外,达仕科技的产品还包括智能自动化包装线和转塔式分选机等设备。
据了解,达仕科技智能自动化包装线可实现半导体前道、后道工序之间的自动化流转、检测、打包等工序,配套包装线的软件和硬件标准平台都为达仕科技自研。该设备最大特点是进行了模块化设计,可实现功能模块化、调用灵活化、系统集成化。客户可根据实际需求,选择不同功能模块进行自由组合。另外,客户也可在工序之前添加自动检测功能,以确保元器件的可靠性。
此外,包装线也可整合高端打标系统、自动检测影像系统、真空包装系统,可支持晶圆厂和封测厂的FOSB、HWS、FOUP、TRAY等的包装出货,可大大降低劳动人力需求强度及发货出错率,使包装工序的产出多3-4倍。达仕科技自主研发的Auto-Packing System控制中心也可与客户厂内的ERP、PLM、MES和WMS等系统连接,实现统一调度,助力客户实现更高质量、更高效率的智能生产。
针对分选机产品,达仕科技拥有近20年的稳定量产测试经验,并拥有多项转塔设备专利,是国内最早达到国际水平的转塔设备供应商。
达仕科技,助力半导体封测业快速发展
不难发现,在半导体设备领域,非常依赖技术的积累和时间的沉淀。而达仕科技正是如此,其每一款设备都具备其自有的专利技术和自主知识产权。自1996年成立以来,达仕科技注重研发创新,一步一个脚印,慢慢积累慢慢成长,不仅在产品上取得一个又一个突破和成果,在市场上也不断开拓进取,提升行业份额。截止2023年,达仕科技湖州总部工厂落成,年产值超8亿。
长久以来,全球半导体设备市场主要被美日企业垄断,行业进口依赖度较高。随着国产替代加速,逐渐完备的中国半导体产业链将成为必然趋势。
达仕科技作为一家立足本地、深耕中国、面向世界的高科技公司,专注于全球高端半导体封测设备和工厂智能化的研发应用。在封测设备领域提供高端设备,如激光划片机、热压合覆晶键合机、转塔式分选机、智能自动化包装线等装备。
未来,达仕科技将持续加大对新技术、新工艺的研发投入,并不断进行技术改造及产品创新,扩大市场规模,实现规模与效益并增,力争成为全球高端半导体封测设备行业的领航人,助推封测产业实现新升级。
责任编辑:sophie
相关文章
-

- 半导体行业观察
-

- 摩尔芯闻
最新新闻
热门文章 本日 七天 本月
- 1 当我拿出 4 卡 GPU 测试 Ansys 流体仿真,阁下该如何应对?
- 2 英飞凌2024汽车创新峰会:揭秘全球汽车芯片No.1供应商的创新与布局
- 3 收购GaN Systems后,英飞凌氮化镓迎来新突破
- 4 ADI携4大产品线亮相上海慕展,引领智能边缘行业新升级
- 5 迈来芯亮相上海慕展,解析技术创新布局与中国本土化战略
