群雄竞逐先进封装,后道制造迎来拐点
2022-03-21
14:17:26
来源: 李晨光
点击
随着摩尔定律的演进,芯片制造成本和难度越来越高,依靠制程缩小去减小体积、提高性能的难度越来越大,先进封装技术成为满足电子产品小型化、多功能化、 降低功耗、提高带宽等高需求的重要途径。
同时,随着5G、物联网、汽车电子和高性能计算等在内的应用不断要求芯片技术精进,也在不断推进更高端的封装技术,先进封装的重要性日益凸显。
据Yole数据,2021年全球封装市场规模约达777亿美元。其中,先进封装全球市场规模约350亿美元,预计到2025年先进封装的全球市场规模将达到420亿美元,2019-2025年全球先进封装市场的CAGR约8%,相比同期整体封装市场(CAGR=5%)和传统封装市场,先进封装市场增速更为显著,将为全球封装市场贡献主要增量。
集成电路产业向前发展的进程当中,原先属于“配角”的封测环节,真正进入到了“芯片成品制造”阶段,成为芯片前道制造和后道制造其中之一的重要组成部分,支撑着整个集成电路向前继续快速地发展。
在此背景和趋势下,封测企业迎来良机。近日,在第十九届中国半导体封装测试技术与市场年会上,长电科技董事兼首席执行长郑力表示,未来全球半导体封装测试市场将在传统工艺保持较大比重的同时,继续向着小型化、集成化、低功耗方向发展,在新兴市场和半导体技术的发展带动下,附加值更高的先进封装将得到越来越多的应用,封装测试市场有望持续增加,先进封装发展的复合增长大大快于传统封装的市场。
前道与后道,趋于模糊
然而,随着先进封装技术的声名鹊起,引来一众行业厂商群雄竞逐。随着封装技术升级至晶圆级别,具有工艺积累的Foundry厂商切入封装业务为客户提供更完整的解决方案,如台积电为锁定大客户订单,满足客户对于产品性能升级需求以及快速交付产品等,也提供先进封装服务。三星、英特尔等IDM厂商亦有布局。Foundry厂商业务的下移造成了先进封装行业多种模式并存的局面,或将给OSTA厂商带来冲击。
对此,郑力表示,与其说“冲击”,也许可以用“良性的刺激”这个说法能更好地表现我们实际的感受。“到了异构集成阶段,已经不仅仅是由封测这个环节可以完全承担下来的,也不仅仅是由晶圆制造这个前道工序可以完全承担下来的。它包括了设计、前道的晶圆制造和后道制造,共同形成一个组合拳来形成异构集成。2.5D/3D封装以及Chiplet都是这样的方向,正在要求芯片设计、制造、封测企业从以往的“单打独斗”,转向资源整合与协作。
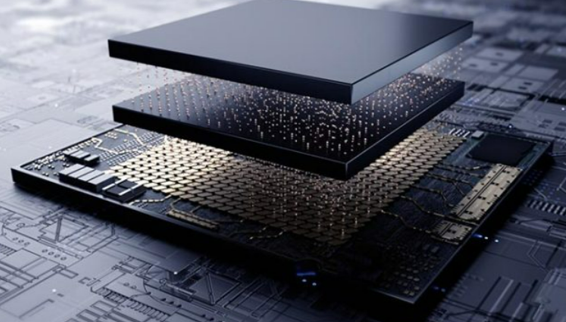
近年来,前道制造和后道制造,包括设计环节都在积极地参与到异构集成、2.5D/3D封装的联合阵线上来。将来可以看到在前道制造里面会有后道制造的元素在,后道制造中也会有更多的前道技术元素。这非常贴切地表述了现在前道、后道之间的紧密结合的过程,反映出了产业协同向前发展的必然趋势,前道制造在向后走,后道制造也在向前走的时候,难免中间会出现共通的领域(比如TSV打孔)。但大的方向毫无疑问是前道制造和后道制造做各自擅长的事情,最后把它形成芯片成品。”
可以看到,如今的封装技术已经进入到了一个新时代,随着技术与应用需求的演进,芯片产业链上的各个环节已不再像过去那样泾渭分明。如果封测厂商希望能在先进封装领域拥有一席之地,需要顺应时代发展,充分发挥自身技术积累,同时拓展技术能力。
对后道制造来讲,对晶圆级封装技术的投入越来越多。郑力介绍道,长电科技在将近20年前已经开展了晶圆的封装技术,进行了大量的专利和技术开发的工作。后道制造一方面是更加专注于把不同的晶圆或者不同的die进行高密度的集合,把做好的晶圆更高密度的叠加在一起;另一方面是对不同的晶圆或chip之间高密度互联做进一步的工作。
据悉,长电科技在去年推出的XDFOI系列扇出型封装解决方案,就是在晶圆级封装技术上的布局和演进,XDFOI是一种以2.5D TSV-less为基本技术平台的封装技术,在线宽/线距可达到2μm/2μm 的同时,还可以实现多层布线层,以及2D/2.5D和3D多种异构封装,能够提供Chiplet及异构封装的系统封装解决方案。
此外,在后道制造的环节,设计的元素也将会越来越深入。可以看到,国际头部的封测企业,当前在设计人员方面的引入,包括在设计方面的工作越来越激进,来配合设计公司在后道制造的过程中如何把复杂的制造流程和设计流程更好地协同,这也是未来在后道制造当中一个重要的技术突破,就是和软件和设计工具充分地结合。
北京超弦存储器研究院执行副院长赵超也曾表示:“封测厂如果希望进入先进封装领域,需要学习代工企业的经营模式,建立强大的技术服务队伍,充分了解全行业对先进封装技术的要求,同时在芯片设计阶段即开始介入,更好的进行协同优化布局”
如何看待Chiplet技术的发展?
后摩尔时代,先进封装技术大有可为,后道成品制造在产业链中的地位愈加重要。其中,作为先进封装领域最重要的技术之一,Chiplet技术广受关注。
然而,由于Chiplet技术缺少统一的接口标准,造成了各种异构芯片的互连接口和标准设计在技术和市场竞争方面难以平衡性能和灵活性。近日,英特尔联合台积电、AMD、Arm、日月光等十家半导体企业成立了Chiplet标准联盟,正式推出了通用Chiplet的高速互联标准“UCIe”,旨在定义一个开放的、可互操作的Chiplet生态系统标准。
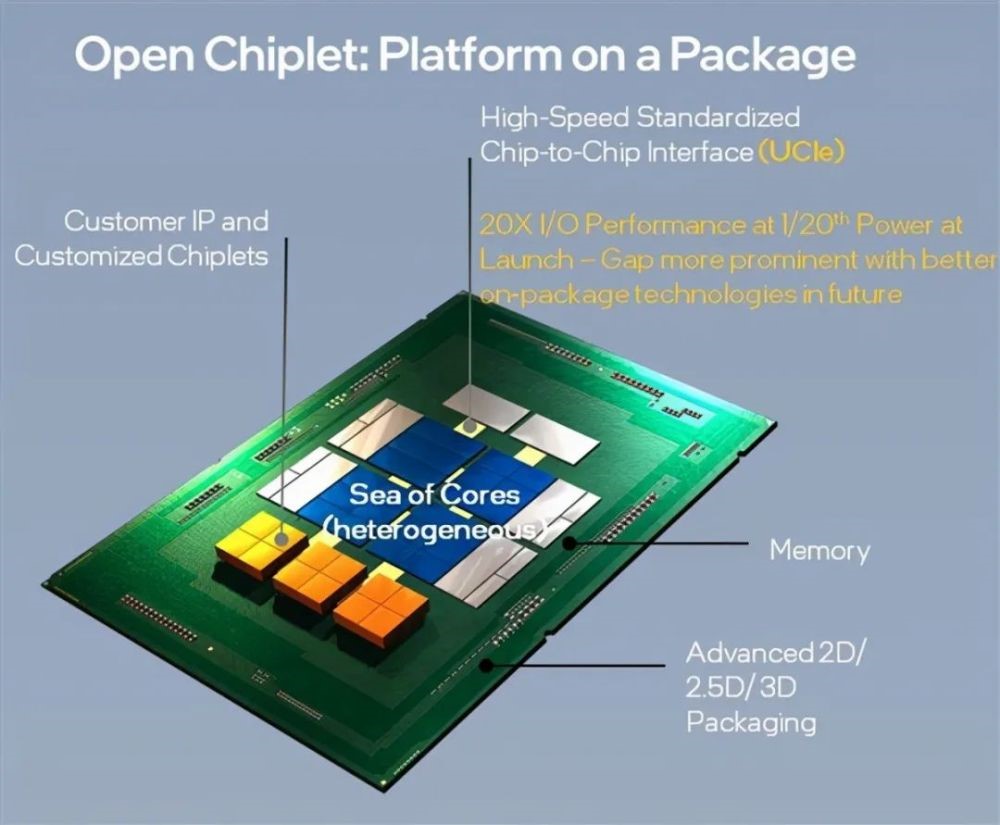
然而,这个十家半导体巨头中,仅有日月光一家封测企业,且没有大陆厂商的身影。对于包括长电科技在内的封测厂商而言,未来的路该怎么走?
郑力表示,这两三年来,行业对于Chiplet互连接口的标准问题都在积极地探讨,认为Chiplet需要形成一个事实上的标准化的流程,以避免在市场规模还比较小的过程中造成资源的重复和浪费。因此,UCIe标准是在现在国际行业对Chiplet进行标准化的努力之一。
对于缺少国内厂商的参与,郑力指出,UCIe产业联盟有它对参加成员逐步公开的流程,后边会看到实际上包括长电科技在内的国内厂家都有在积极地参与,包括UCIe在内的几个不同的标准化进程的工作。同时,在国际上还有其他的几个渠道,大家也正在紧锣密鼓地在做相关标准化的工作,这些信息大家也将陆续会看到。
另外,Chiplet本身还处在刚起步阶段,特别是标准化的工作是一个非常漫长的过程。从过去的经验来看,肯定是会有几种不同的考虑和路径,慢慢的也许可以走到一起来。但从心态上来讲,郑力建议行业对这样的标准化不需要太急迫,还是需要有耐心,用逐步发展的过程来看待Chiplet相关的标准化的工作。
长电科技聚焦汽车电子
另一边,从市场层面来看,长电科技的产品、服务和技术涵盖了主流集成电路系统应用,包括网络通讯、移动终端、高性能计算、车载电子、大数据存储、人工智能与物联网、工业智造等诸多领域。
以汽车行业为例,随着汽车智能化程度提升,汽车电子等应用市场也进入了巨大机遇和挑战共存的周期。出于使用安全考虑,汽车对芯片封装的性能和可靠性都有极高要求。更多智能功能的加入,也使汽车行业所需的封装型式越来越多,给上游封测技术和产能都带来了新的考验。
对此,长电科技积极响应市场需求和产业发展趋势,成立了“设计服务事业中心”与“汽车电子事业中心”,以更专业的平台为客户提供更全面的技术支持。
郑力表示:“目前来看,在长电科技总的盘子里,相比于通信、消费等其它几个领域来讲,汽车电子芯片所占的比例有待提高,这也确实是长电科技未来要发力去发展的一个领域。今后几年随着整个汽车‘四化’进一步的发展,对汽车芯片的需求又会有一波新的大幅度提升。通过成立新的汽车电子事业部,使长电科技得以强化与客户的紧密合作,持续提高长电科技车规产品体系整合和系统完善,使制造到应用的链条更具效率。”
综合来看,长电科技这些举措将进一步扩充公司的商业版图,带来新的业绩增长点。而类似的做法如果在不断实践与检验中在业内形成规模化推广,或许会对国内集成电路产业链带来新的增长驱动力,全面提升行业竞争力。
写在最后
长电科技在2021年率先提出以“芯片成品制造”来重新定义进入先进封装时代的封测行业。芯片成品制造技术正推动产业链的整体发展,深刻地改变集成电路产业链形态,并驱动包括芯片设计、晶圆制造、装备、材料等产业链上下游共同发生革命性变化,全产业链更紧密的协同发展已呼之欲出。
郑力表示:“先进封装或者说芯片成品制造,将成为后摩尔时代重要颠覆性技术之一,特别是后道成品制造在产业链中的地位愈发重要,有望成为集成电路产业新的制高点。”
伴随着产业发展和市场需求,长电科技作为市场规模中国大陆第一、全球第三的芯片成品制造领军企业,不仅以专业化、国际化管理积极开拓全球市场、强化技术积累,保持稳健的业绩增长,同时也积极发挥龙头企业的带头作用,投身于产业链上下游深度合作,带动行业内各领域的整体进步。

郑力对加强产业协同,共建和谐产业链发展提出关键倡议——“合作、人才、创新”,应不断加强国内外、上下游产业链、企业间的多样协作和紧密合作,建立更加完善的行业人才、行业企业家人才培养机制;同时,应进一步的建立和完善对技术创新、知识产权保护相关机制,充分发挥龙头企业的引领作用。
未来,长电科技仍将继续发挥自身优势,携手各方共建健康、开放的产业链生态,为中国半导体产业发展做出更大贡献。
责任编辑:sophie
-

- 半导体行业观察
-

- 摩尔芯闻