SiP专家齐聚慕尼黑丨第二届中国国际系统级封装研讨会亮点多
2020-07-09
12:48:39
来源: 互联网
点击
2020年7月3日,由《慕尼黑上海电子展》与《半导体行业观察》联合主办的“第二届中国国际系统级封装研讨会”在上海国家会展中心如期举行。
中国半导体协会数据显示,在2019年封测市场,中国大陆占比达到28%,仅次于中国台湾。尽管我国封测产业实现了快速发展,但也需看到,在先进封装领域,我国大陆企业与国际龙头仍存在较大差距,且在台积电、三星等晶圆和IDM厂商持续加码先进封装的情况下,围绕先进封装技术的争夺会更加激烈。
在5G通讯被快速推广的今天,我国大陆企业亟需卡位先进封装,把握市场机遇,提升在中高端市场的竞争力与国际话语权,推动我国封测产业的高质量、高端化发展。5G、高性能计算、汽车电子、CIS是拉动封装产业成长的重要动能,在5G方面,由于5G芯片天线数量激增且可用面积维持不变,SiP封装成为厂商的理想解决方案。
第二届中国国际系统级封装研讨会研讨会首次开启线下研讨与线上直播同步进行,十余家半导体行业权威媒体共同支持。参与此次研讨会的演讲嘉宾包括通富微电先进封装研究所副总经理谢鸿博士,速显微电子董事长兼CTO项天,碳码科技总经理杜岗,紫光展锐封装技术资源部部长付发田、天风证券半导体高级分析师陈俊杰以及摩尔精英封装事业部副总裁唐伟炜。

座无虚席的研讨会现场
 互动提问的观众朋友
互动提问的观众朋友通富微电高级封装研究所副总经理谢鸿博士

通富微电是中国前三大集成电路封测企业。谢鸿博士讲到,随着摩尔定律逐渐走到尽头,超越摩尔定律发展的想法在半导体从业人员的脑海里更清晰了。在这样的大环境下, SiP封装技术重新走到了聚光灯下。从一味追求功耗下降及性能提升(摩尔定律),转向更加务实的满足市场的需求(超越摩尔定律), SiP是实现这个目标的重要路径。
SiP将在移动、计算、通信、汽车和工业应用中发挥关键作用。他还介绍了SiP在各大国际厂商中的应用,包括iPhone手机中的应用,Microchip的Wi-Fi模块也使用SiP来缩小模块的大小和成本。另外,Xilinx,AMD,Nvidia,Broadcom,Google,百度等的具有HBM的硅中介层现已投入生产。英特尔将EMIB硅桥嵌入在层压基板中,用于CPU,AI加速器,现已投入生产。Fan-out技术也在扩大生产,日月光的FOCoS和台积电与InFO_MS生产等等。
封装架构从传统的LF、QFN、BGA到先进的封装技术,如FO、Si interposer、3D等,融合了所有传统和先进的封装技术。对于汽车应用来说,需要在车载雷达(24GHz / 76GHz)、5G移动设备(28GHz/ 60GHz)等领域的拓展,再就是基板的介电特性、电磁兼容、下填充对射频器件来说变得越来越重要。
在5G到来的时代,设计和仿真能力(RF设计、建模和仿真工具)需要继续进步,以跟上不断增长的信号速度和带宽需求。他还提到,将各种封装技术和功能集成到SiP的形式中,是测试技术的一大挑战。对此,谢鸿博士分享了公司在Sip封装上的优势,并介绍了公司与合作伙伴珠海通达半导体有限公司的嵌入式sip封装案例,具有高效、高可靠性、成本效益好等优点。
谢鸿博士表示,SiP在移动,计算,通信,汽车,工业应用中将继续发挥关键作用;封装架构涵盖了从传统的LF,QFN,BGA到先进的封装技术,例如FO,Si中介层,3D以及所有传统和先进封装技术的集成。业界要继续提高仿真、模拟、测试的能力来应对这些应用的需求。
速显微电子董事长兼CTO项天

速显微电子被称为物联网时代的UI美化大师。项天表示,在物联网、5G技术日趋成熟,人工智能、数字经济蓬勃发展的今天,显示技术作为数字化迈向智能化领域不可或缺的重要环节,在构建万物互联互通的智能世界中扮演越来越重要角色。物联网时代,显示无处不在,5G和IoT将深刻改变行业。那么该用什么去绘制屏幕?是CPU还是MCU?
CPU功能多、性能好且第三方的资源比较多,但是系统移植困难,底层支持不甚理想,bom成本比较高,功耗也比较大。MCU的成本低,且系统精简,开发简单,底层驱动使用容易,但是图形性能不足。有没有折衷的方案?
速显微耗时5年,通过把GPU放到MCU里!打造出一站式综合平台。GPU内核完全自主,主芯片采用集成GPU的双核MCU,内置速显微自研的图形显示芯片GC9003,快速的图形,刷新速率,可显示任意中心旋转、系统动画、自定义动画等复杂界面。

其中AHMI是全球唯一面向MCU的GPU IP,参考OpenGL 1.5,实现固定管线的功能,支持3D效果,可集成于MCU,面积占用小,可运行在RTOS,CPU开销少,目前已实现量产。
项天在会上发出疑问三连:做一颗图形MCU最重要的是什么?做一颗图形MCU第二重要的是什么?还有么?以下是他的解释。
做一颗图形MCU最重要的是什么?那就是一颗芯片实现所有。速显的GC900采用BGA132封装,SiP五颗DIE,一颗主DIE,两颗Flash,两颗SDRAM。
做一颗图形MCU第二重要的是什么?速显独有的IDE工具链,可在网络客户端或本地客户端实现无代码二次开发工程。入门简单,且开发效果好。为广大客户节省了大量的产品迭代开发时间,降低研发成本。
还有么?效果要好,功能要多。
这些还不够,速显微正在联合多方资源,设计一个开源GPU内核。速显微电子一直做图形MCU及生态环境探索者。
碳码科技总经理杜岗博士

碳码科技是一家专业的医学数据处理公司,致力于人工智能在疾病诊断的应用,包括心律失常、肿瘤及代谢疾病诊断等领域。杜岗博士提到,在医学领域,心脏起搏器及ICD等是目前我国生物材料产业中的短板,国产化率不到5%。高附加值产品几乎全被国外占领,这些领域都存在国产替代的市场机会。在将来,产品的智能化是发展的趋势,而发展的驱动力来源于基于自主知识产权的解决方案,包括硬件、算法及数据。低功耗、高性能的生物信号采集芯片是研发具有国际竞争力产品的核心,SIP封装是目前的重要解决途径之一;同时,包括临床专家、芯片设计工程师、算法工程师在内的跨界团队组合非常重要。杜岗博士还分享了一些先进芯片设计、微纳米技术在医学智能硬件、体外诊断、肿瘤早期筛查中的应用前景。
最后,他呼吁业界能够将更多的精力放在医疗领域,不要急功近利,为我国医疗事业做出贡献。
紫光展锐封装技术资源部部长付发田

紫光展锐是我国集成电路设计产业的龙头企业。付发田主要分5大部分介绍了封装产业化发展的整体情况,包括产业发展面临的硬件集成困局、SIP是解决产业困局的有效方法、先进封装技术拓展了SIP的集成能力、SIP产品设计的注意事项、开放合作是产业发展的方向。
目前电子行业面临的挑战是需求的发展速度快过产业支撑能力的发展。硬件是各类电子产品功能实现的载体,硬件发展的核心是“集成”。过去几十年,以摩尔定律为主导的芯片集成度的不断提升支撑了电子产业的发展,但是先进工艺在性能提升的同时晶圆制造成本也大幅上升,物理的限制传统摩尔定律已经走向终结。以晶圆集成度不断提升为支撑的硬件集成发展通道已经很难延续,此外,可穿戴、多功能、便携等需求严重限制了板级硬件集成能力。为此,SIP封装开始逐渐登上历史舞台,SIP封装(System In a Package系统级封装)是将多种功能晶圆,包括处理器、存储器等功能晶圆集成在一个封装内,从而实现一个基本完整的功能。它与SOC(System On a Chip系统级芯片)相对应。不同的是,系统级封装是采用不同晶圆进行并排或叠加的封装方式,而SOC则是高度集成的芯片产品。
“业内技术领导企业已经布局SIP研发多年并取得很好的产品收益,第一梯队的厂商正积极跟进SIP模组的开发”付发田在会上谈到。
他表示,在行业发展转变的时间点应充分挖掘封装技术的潜力,重视先进封装技术的产品应用。近几年各封装厂商、晶圆厂商均大力投入先进封装技术的研究,新的技术频繁涌现、百花齐放,例如多Die Fanout技术、2.5D封装、3D封装技术、IP芯片的射频/EMI屏蔽技术等等,这些成熟封装技术的混合应用有效的拓展了SIP的集成能力。
确实,实现技术的多样化给芯片(SIP)厂商带来了技术选型的困难,不同技术在性能上也有差异,对批量生产的成本、产能也带来巨大挑战。“在现实需求的压迫下、在封装新技术的支撑下,我们已经看到在封装领域面临着巨大的发展机,也为全产业链的参与厂商提供了更广阔的合作空间。”他在会上谈到。
因此,他强调,开放合作将是产业的发展方向,紫光展锐是一家比较开放的厂商,也期待不同技术及各封装厂商间的互通、共享、标准化。他希望SIP封装这个昔日王谢堂前燕,能够尽快地飞入寻常百姓家。
天风证券半导体高级分析师陈俊杰

天风证券是拥有全牌照的全国性综合类上市证券公司。陈俊杰首先从设计、集成和封装三方面对比分析了SoC和SiP两者的差别:从设计的角度出发,SoC是将系统所需的组件高度集成到一块芯片上。SiP 是从封装的立场出发,将多个具有不同功能的有源电子元件与可选无源器件,以及诸如MEMS 或者光学器件等其他器件优先组装到一起,实现一定功能的单个标准封装件;从集成度而言,一般情况下,SoC 只集成AP 之类的逻辑系统,而SiP 集成了AP+mobile DDR;从封装发展的角度来看,SoC 的发展面临瓶颈,进而使SiP 的发展越来越被业界重视。

因此,SiP是超越摩尔定律的必然选择路径。陈俊杰谈到,SiP是解决系统桎梏的胜负手。把多个半导体芯片和无源器件封装在同一个芯片内,组成一个系统级的芯片,而不再用PCB板来作为承载芯片连接之间的载体,可以解决因为PCB自身的先天不足带来系统性能遇到瓶颈的问题。
“我们认为,SiP不仅简单将芯片集成在一起。SiP还具有开发周期短、功能更多、功耗更低、性能更优良、成本价格更低、体积更小、质量更轻等优点。”陈俊杰强调。
SiP可以用在多种应用领域,包括无线通讯领域、汽车电子、医疗电子等等,但是SiP可以说是为手机量身定制,手机是SiP封装最大的市场。随着智能手机越做越轻薄,对于SiP 的需求自然水涨船高。从2011-2015,各个品牌的手机厚度都在不断缩减。轻薄化对组装部件的厚度自然有越来越高的要求。
陈俊杰还谈到,从制造到封测,SiP 产业链将逐渐融合。由于封测厂几乎难以向上游跨足晶圆代工领域,而晶圆代工厂却能基于制程技术优势跨足下游封测代工,尤其是在高阶SiP 领域方面。因此越来越多的晶圆代工厂开始跨入SiP封装业务,将与封测厂从单纯上下游合作关系,转向微妙的竞合关系。
摩尔精英封装事业部副总裁唐伟炜

摩尔精英是领先的芯片生态链平台,使命是“让中国没有难做的芯片”。
唐伟炜首先介绍到,SiP是系统级的多芯片封装,能够完成独立的系统功能。SiP是3D立体化的多芯片封装,其3D主要体现在芯片堆叠和基板腔体上,同时,SiP的规模和所能完成的功能也比MCM有较大提升。SiP技术的优势主要体现在周期短、成本低、易成功方面。实现同样的功能,SiP只需要SoC研发时间的10-20%,成本的10-15%左右,并且更容易取得成功。因此,SiP被很多行业用户作为SOC建设的低成本、短期替代方案,SOC项目开始以SiP作为先行者,迅速且低成本地做出SiP产品,当SiP在项目上取得一定的阶段性成果之后,收到多方认可和支持,再将重心转到SOC研发。
他指出,智能硬件是极度碎片化市场,中国有5万多家智能硬件企业,2000+多家芯片公司,大陆电路板年出货量年复合增长率12%。随着SiP市场需求的增加,SiP封装行业的痛点也开始凸显,例如无SiP行业标准,缺少内部裸片资源,SiP研发和量产困难,SiP模块和封装设计有难度。因此,SIP市场需要设计、仿真、打样、量产一站式的服务需求。
针对以上SiP的难点和痛点,唐伟炜介绍了摩尔精英在SiP方面拥有的优势。摩尔精英具有平均工作经验超过15年的SiP开发的工程师团队、世界一流封装厂进行量产以保证质量与良率、且有丰富的国内外800多家Fabless和国外57家主流IDM公司的裸片资源、还拥有成熟的SiP设计及量产方案,在保证质量的前提下缩短time to market。
最后,唐伟炜跟大家分享了摩尔精英的四个量产项目,从这四个量产项目可以看出,无论是尺寸还是价格上,SiP封装的优势都非常明显。
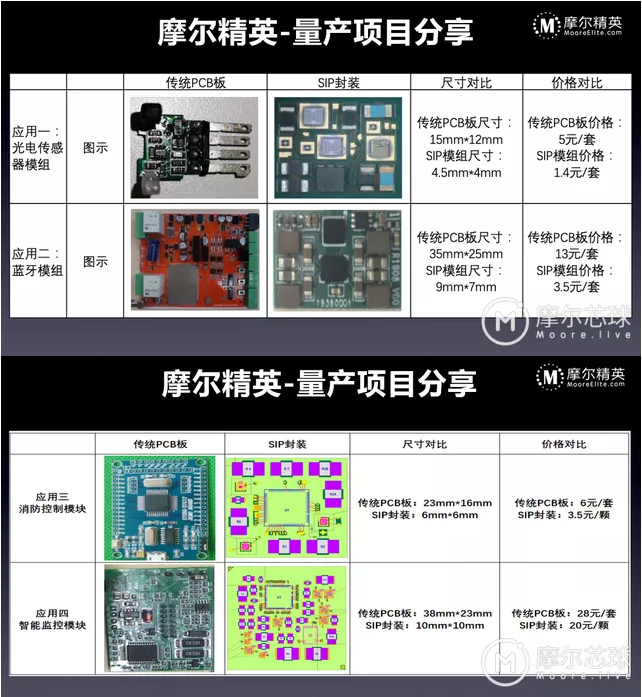
摩尔精英的目标是用1/10的资金,1/10的团队,1/10的时间完成芯片设计,让中国没有难做的芯片。

随着半导体技术的不断发展,为了满足越来越多的应用需求,电子封装体正朝着小型化、微型化发展,系统级封装技术(SiP)越来越受到重视。在5G通讯被快速推广的今天,我们希望中国的封装产业能借此研讨会机会,在海外高端产品市场站稳脚跟、逐步实现医疗工业设备国产化替代。
中国国际系统级封装研讨会,我们明年见。

如果您有封装业务的需求
请扫码留下您的需求信息
将会有专业顾问和您联系
责任编辑:sophie
-

- 半导体行业观察
-

- 摩尔芯闻
最新新闻
热门文章 本日 七天 本月
- 1 2024北京车展黑芝麻智能揭晓武当系列项目落地和生态链合作新图景
- 2 地平线发布征程6和高阶城区智驾样板间,以顶级的软硬结合全栈技术加速智驾平权
- 3 OPPO 20周年,首次发布创新与知识产权白皮书
- 4 收藏,半导体一些术语的中英文对照
