系统级封装SiP整合设计的优势与挑战
2021-05-25
15:23:08
来源: 互联网
点击
应对系统级封装SiP高速发展期,环旭电子先进制程研发中心暨微小化模块事业处副总经理赵健先生在系统级封装大会SiP Conference 2021上海站上,分享系统级封装SiP技术优势、核心竞争力及整合设计与制程上的挑战,获得热列回响。


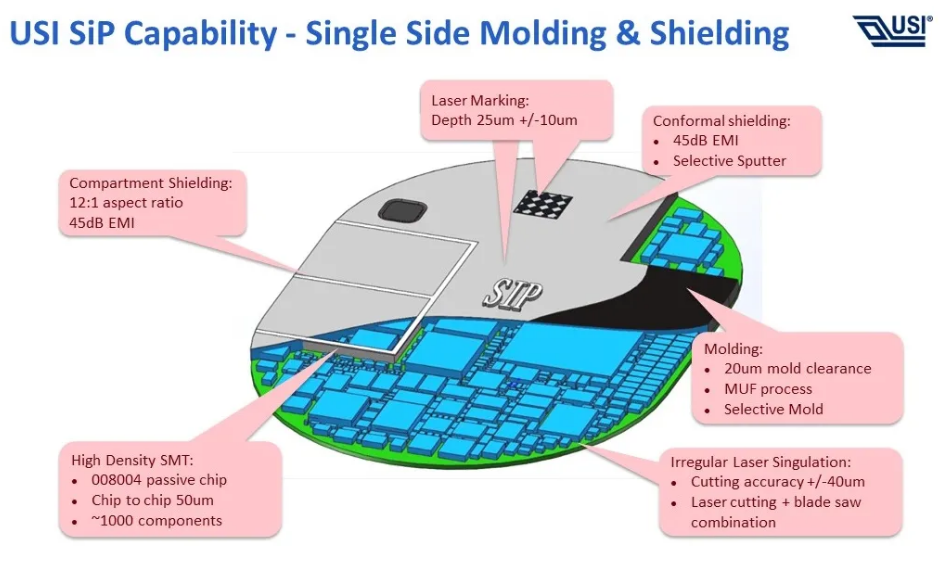



系统级封装SiP的微小化优势显而易见,通过改变模组及XYZ尺寸缩小提供终端产品更大的电池空间,集成更多的功能;通过异质整合减少组装厂的工序,加上更高度自动化的工艺在前端集成,降低产业链复杂度;此外,系统级封装SiP实现更好的电磁屏蔽功能,运用模塑(Molding Compound)加上溅镀(Sputter)或喷涂(Spray Coating)技术,实现对外界电磁辐射的屏蔽与模块内部不同功能之间的屏蔽,特别适用于频段越来越多的5G mmWave模块与TWS真无线蓝牙耳机等。
另一方面,借由日月光和客户共同设计的优势与扎实的封测技术到系统组装的综合能力,因应产品上电源管理模块、光学、传感器模块、射频、可编程序存储器(AP Memory)等等功能多样化需求,模组化设计的便利性,更创新设计应用,利用核心竞争力的主板级组装(Board Level)能力,为终端产品设计提供更大的灵活性。
系统级封装的优势

先进的工艺、测试及EE/RF硬件设计能力等将推动系统级封装SiP技术不断创新,整体工艺成本将会越来越有优势,其优越的性能将越来越多地应用在更多穿戴产品,如智能眼镜、支持5G和AI的物联网、智能汽车及生物医学等对尺寸有特别要求的应用领域,提供客制化设计与解决方案。
单面塑封
Single Side Molding, SSM
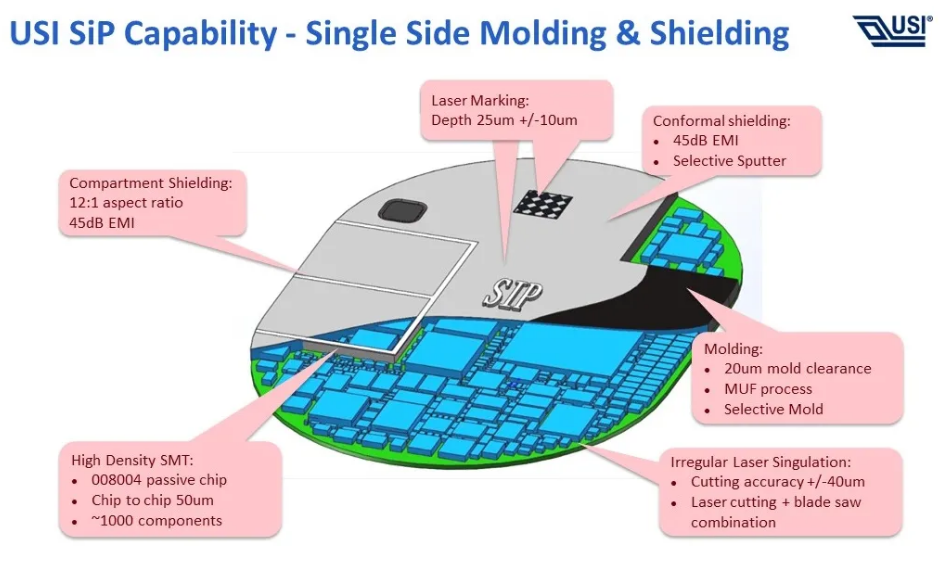
环旭电子系统级封装SiP模块微小化制程技术能力主要有单面塑封(Single Side Molding, SSM)和双面塑封(Double Side Molding, DSM)。其中单面塑封主要核心技术是高密度SiP,以智能手表为例,可运用008004被动元件,间距达50μm,在20毫米左右的主板面积上可置入1000多颗元件;采用Molding形式,不需要Underfill点胶,加上Laser Marking 的能力,更可最大化节省空间与成本。
双面塑封
Double Side Molding, DSM

双面塑封(Double Side Molding, DSM)先进制程技术,为了有效地利用空间集成更多的元器件必须克服制程上的多种困难,尤其在双面模具与屏蔽的制程、Cavity SMT性能的改善,加上铁框与Flex 制程能力的开发,目前已经顺利在2021年导入量产。环旭电子持续在先进制程技术上研究发展,建置SMT并结合打线(Wire Bond)和粘晶(Die Bond) 整合产线,终端产品客户可以直接投入晶圆,直接制造产出模块的整合服务,加快产品的上市时程,也利用扇出型封装连结(Fan Out Interposer)等技术保持电路联通性,确保电路不受高度集成的模块影响,同时增加主板的空间利用率。
日月光与环旭电子深耕合作多年,积累在系统级封装SiP从封测到系统端的组装整体解决方案,未来将提供终端产品客户更优化的设计、制造上的整合与弹性化的营运,发展高性能、微小化模块,加速迎来系统级封装SiP新应用机会。

长按关注
日月光微信公众号
责任编辑:sophie
-

- 半导体行业观察
-

- 摩尔芯闻
最新新闻
热门文章 本日 七天 本月
- 1 高通抢先推出首个5G基带X50:28GHz波段,最高5Gbp
- 2 高通抢先推出首个5G基带X50:28GHz波段,最高5Gbp
- 3 高通推全球首颗5G芯片,下行速度高达5Gbps
- 4 关于iPhone 7 Plus双摄像头的最强解读
- 5 手机供应链缺货危机何时休?

