[原创] 最新的存储器路线图分享
去年IEDM(国际电子器件会议)期间的一个周日的夜晚,TechInsights举办了一场招待会,Arabinda Das和Jeongdong Choe在会上做了演讲,吸引了一屋子的与会者。 Arabinda首先发表了题为“苹果iPhone的十年历程与半导体技术创新”的演讲,随后Jeongdong讨论了“存储器工艺、设计与架构的今天和明天”。
Arabinda粗略回顾了iPhone及其功能组件的开发过程,我们多半已经忘记第一台没有相机、指纹传感器、人脸识别等等功能的iPhone,这绝对唤起了我们的记忆。
Jeongdong对逆向工程专家们所见的最新存储器技术进行了回顾,并对他们最近的分析进行了相当详细的总结,我将在本文中详细介绍这些分析。 Jeongdong是TechInsights公司的高级技术人员,也是他们的存储器技术专家。 在加入TechInsights之前,他曾担任SK海力士和三星开发下一代存储器件的研发团队负责人,因此他非常清楚自己的演讲内容。
NAND Flash Technology
NAND Flash技术
我们先来看看NAND flash,截至2018年11月,前六大制造商的市场份额分别为: 三星36%、东芝19%、西部数字15%、美光13%、SK海力士11%、英特尔6%。
Jeongdong每年都发布存储器路线图,下面是更新后的NAND flash路线图。 你可以看到,我们现在进入了1z-nm平面flash时代(可能是13-14 nm,1y为~15 nm)和有4级单元的~96层3D flash时代。 路线图是基于已发表的预测,但我很难相信我们将在短短三年内达到200多层。
图的底部是过去几年的技术发展,从平面器件中控制栅从硅化物转向钨开始,然后我们从双重曝光转变为四重曝光,得到了小于20nm的特征尺寸。 我们看到了空气间隙(air gaps)的广泛采用(实际上,美光开始于25nm一代),随着15/16nm平面部件的全面生产,3D/V-NAND产品也随之推出。 它们使用两种存储技术,分别是电荷陷阱技术(charge-trap,将电荷存储在氮化硅层上——三星、东芝/西部数据和SK海力士)和浮栅技术(floating gate,美光/英特尔)。
美光/英特尔还采用了一种不同的layout理念,提供了更大的面积数据密度; 他们设计了堆叠,将驱动电路置于阵列之下,从而节省了外围面积,并使芯片更小——他们称之为CMOS-under array (CuA)。 他们的64层产品是2x32层堆叠,而96层使用2x48层堆叠。
展望未来,路线图显示最后将多达256层,除了小众应用之外,平面器件将会淡出。 “4D NAND”似乎是SK海力士版本的CuA,而Xtacking则是YMTC在阵列上堆叠CMOS以节省面积的工艺。

关于平面器件,我们有以下主要厂家的产品序列:
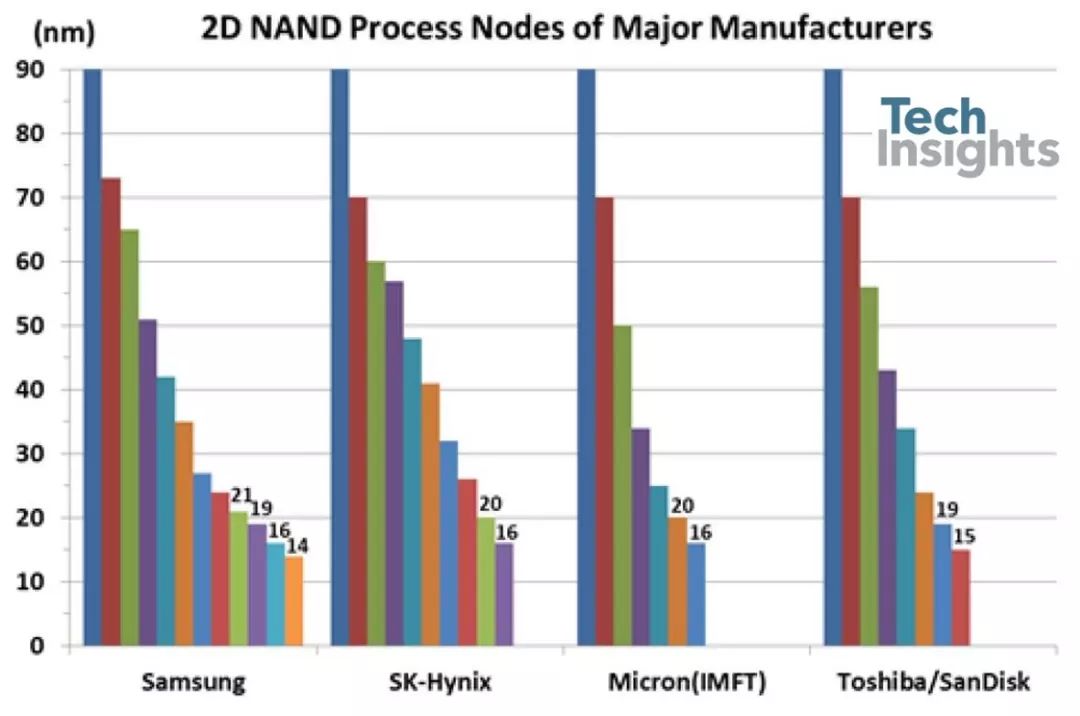
目前为止看到的最小的半节距是三星的14nm 128-Gb芯片,block尺寸是152个单元:


我们可以看到英特尔部件的CuA是如何将阵列效率提高到接近90%,从而得到了256-Gb组中最小的芯片。 来自iPhone XS Max的SK海力士512-Gb芯片具有几乎相同的内存密度,比256-GB部件有了惊人的改进。
从48层技术向64层技术过渡的一个发展是蚀刻用于接触3D-NAND器件中的字线(wordlines)的“阶梯”。 例如,在东芝/西部数据的部件中,由于蚀刻工艺的改进和修整掩模的更改,阶梯的宽度缩小了45%。
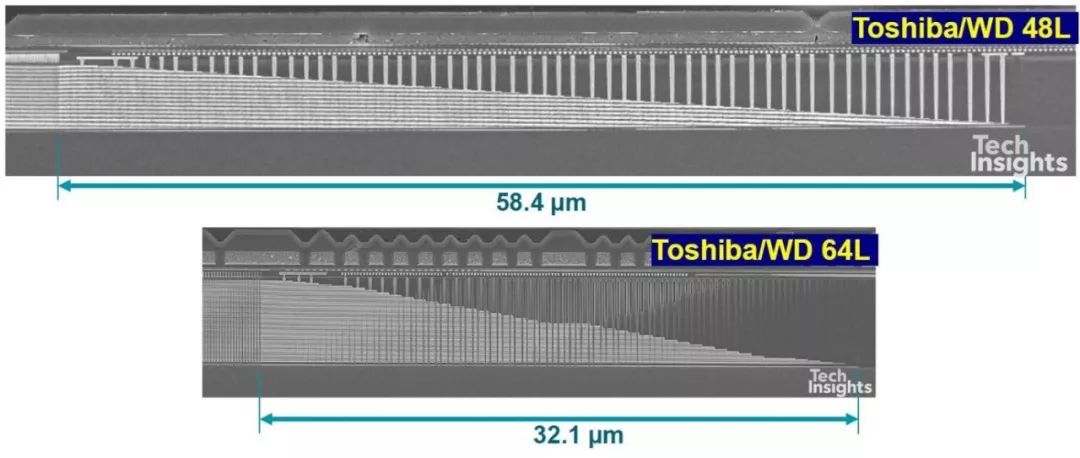
即使缩小后阶梯仅占芯片面积的0.82%,这也不是微不足道的。 同样,三星的阶梯宽度减小了27%,阶梯面积仅占0.44%。

我们还可以比较英特尔/美光的三级和四级单元部件; 即使它们都是20nm和64层,位密度从4.4 GB/mm2增加到6.5 GB/mm2,几乎增加了50%。 我们现在正处于太比特芯片时代,美光公司刚刚发布了1-TB micro-SD 卡,内置8个1-Tb芯片!

在上面的幻灯片中,晶体管级芯片的照片很小,但它们确实可以很好地放大:

在这些照片中,我们可以清楚地看到阵列下面的电路密度。 接下来是SK Hynix 3D-NAND,它使用了折叠结构。
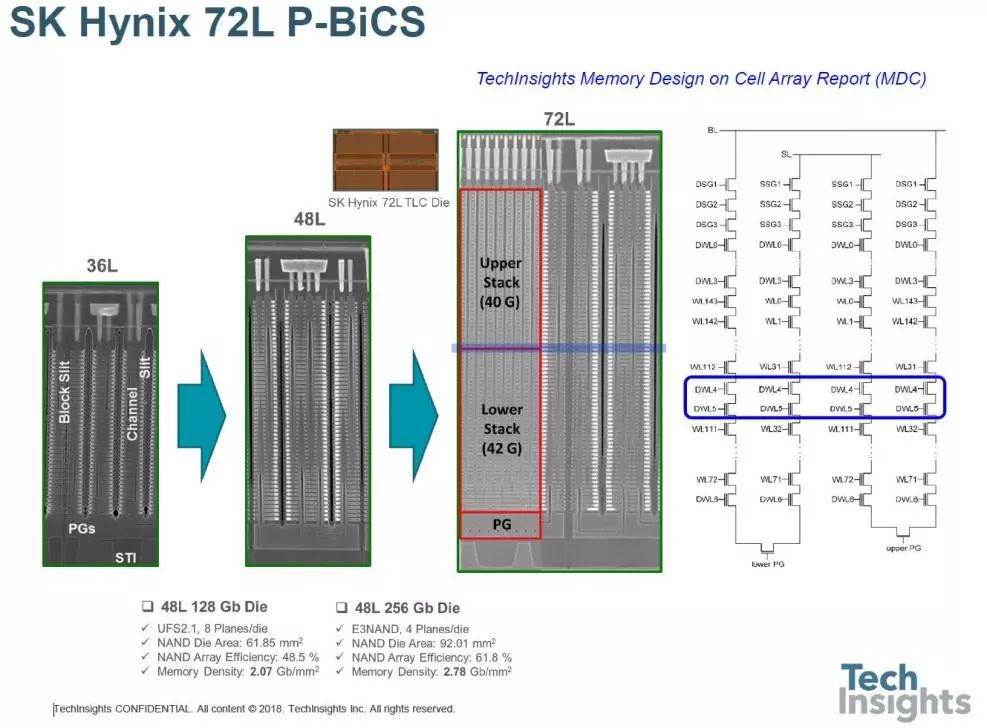
如果我们仔细观察,我们可以看到堆叠从36 - 48 - 72层的演变。 36L器件只有一个旁通栅(pass gate),而48L和72L有两个旁通栅,允许两个单元链的公共位线和源线。 72L堆叠的中心图像有点混乱,因为它有两个正交的图像合在一起——右侧是与位线平行的部分,左侧是垂直于它们的部分。 如果我们查看分离的图像,PG区域中的孔显示左侧部分穿过两个管道栅的下部,而在顶部可以看到各个位线。
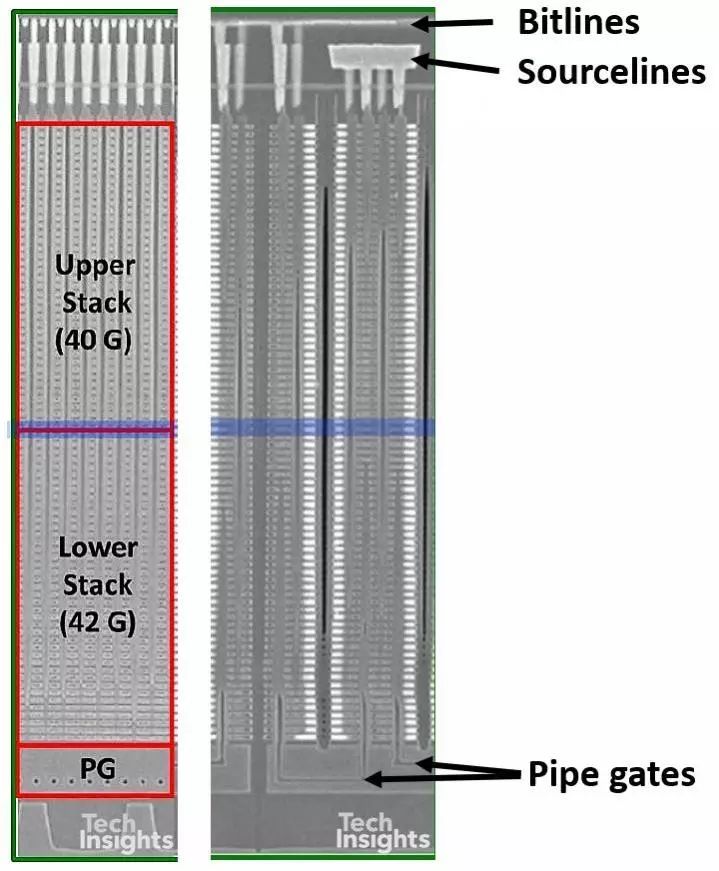
上部和下部堆叠指的是82个栅极堆叠的两级结构。 Jeongdong在这次演讲中没有详细说明,但是他去年6月在EETimes上发表了一篇博客,阐明了通道孔是采用两步蚀刻工艺形成的。 估计的工艺顺序是:
· 管道栅极模具成型(下部)
· 通道蚀刻(下部,42个栅极)
· 牺牲层填入孔中
· 模具成型(上部)
· 通道蚀刻(上部,40个栅极)
· 牺牲层去除
· 通道形成
这些缝隙和子缝隙是通过一步蚀刻整个堆叠而形成的。 在上面的回路原理图中,蓝色轮廓显示了顶部堆叠和底部堆叠之间的两条虚拟字线的位置,横截面中用蓝线标记。 详细的堆叠将在下一张幻灯片中给出:
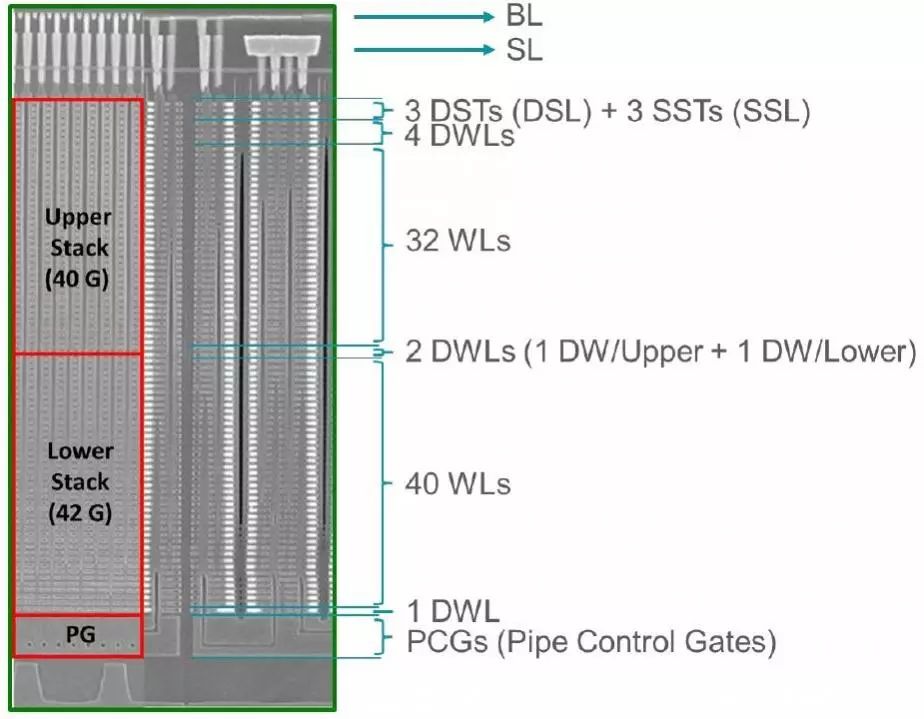
演讲讨论的最后一个NAND器件是去年在闪存峰会上展示的YMTC 64L部件。 这是他们的第二代3D-NAND技术,使用Xtacking将外围电路放在存储器阵列的顶部,而不是放在下面。 YMTC采用面对面晶圆键合:
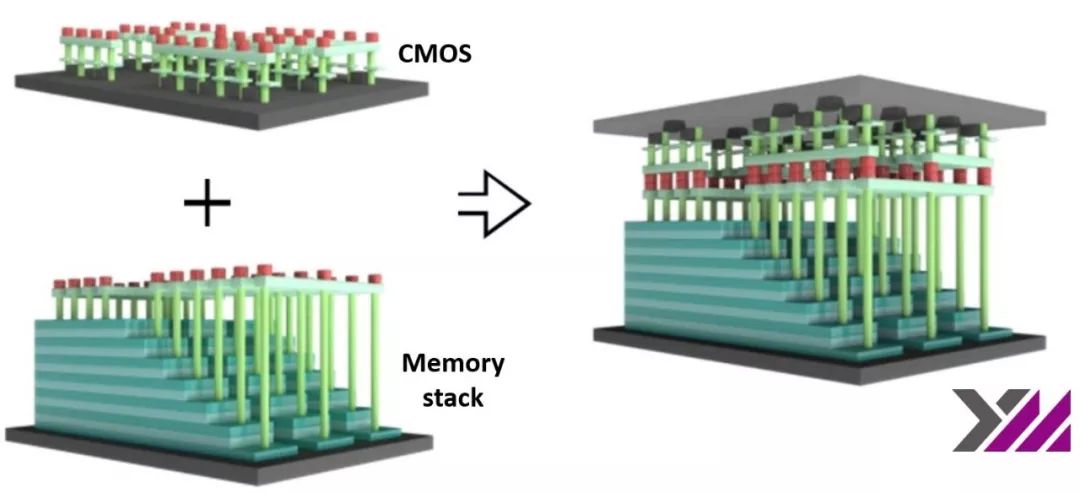
我在Jeongdong使用的图片上做了注解,以此注明我们看的东西:
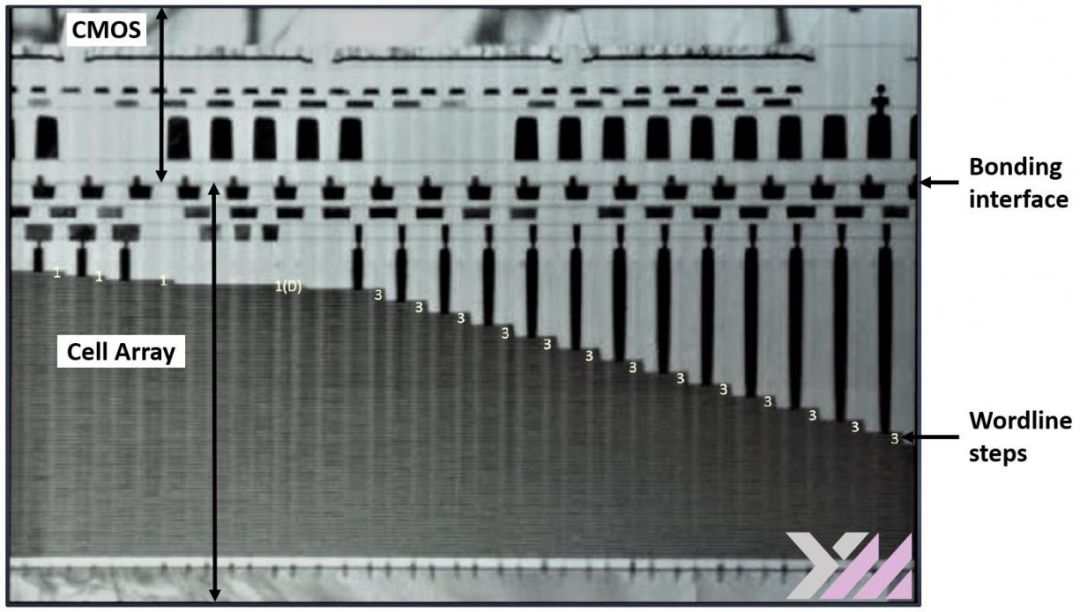
我们在阵列的边缘有典型的阶梯,它们有助于增加每一步的字线数量,表明在顶部有一条虚拟字线,在单独遮罩的选择栅极下面。
晶片键合为我们提供了总共七个达马色金属层,三个在阵列中,四个在CMOS中,在单元堆叠中总共有74个钨字线。 在YMTC的任何声明中都没有特别提到这一点,但从历史上看,他们与Spansion(现在是Cypress)紧密合作,在NOR闪存中使用电荷陷阱存储,因此他们的3D-NAND似乎也是基于电荷陷阱的。
这种结合可能是来自Xperi的DBI®(直接键合互连)技术——它是上面非常模糊的TEM图像,但它看起来与索尼IMX260堆叠图像传感器(下图)的SEM横截面中的界面类似,我们知道它的工艺。
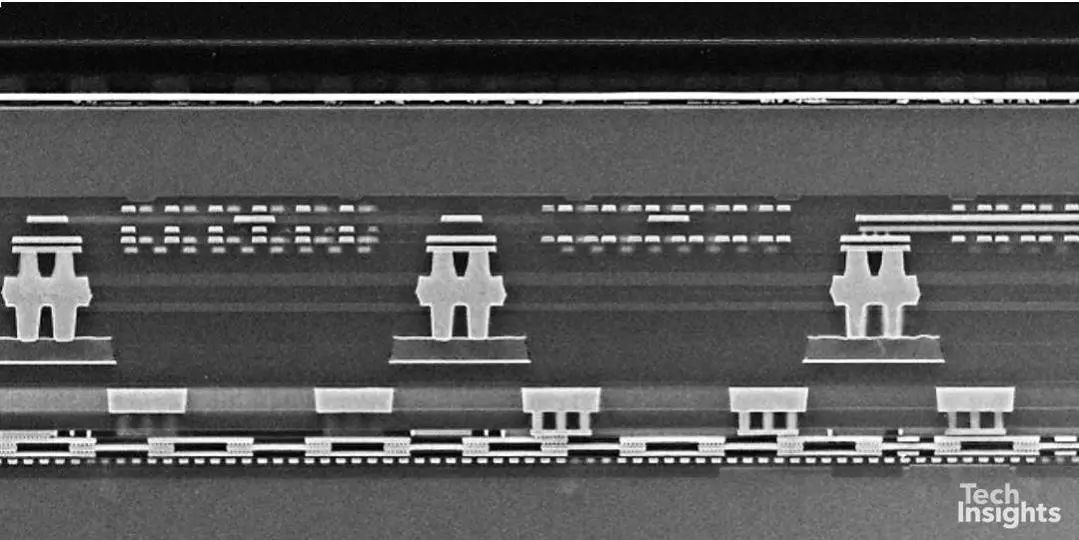
Jeongdong用几张总结幻灯片结束了NAND flash部分,第一张幻灯片描述了到目前为止3D NAND的创新。这张幻灯片很热门,所以我就不细讲了,里面有很多创新!除了3D堆叠本身外,还有一些意想不到的功能,如外延(SEG)晶体管(三星)、CuA、双串堆叠(美光),以及管道栅极(SK海力士)。现在,我们拥有了晶圆键合!

摘要幻灯片跟踪了到目前为止的进展情况,并提出了对未来发展的一些关注:
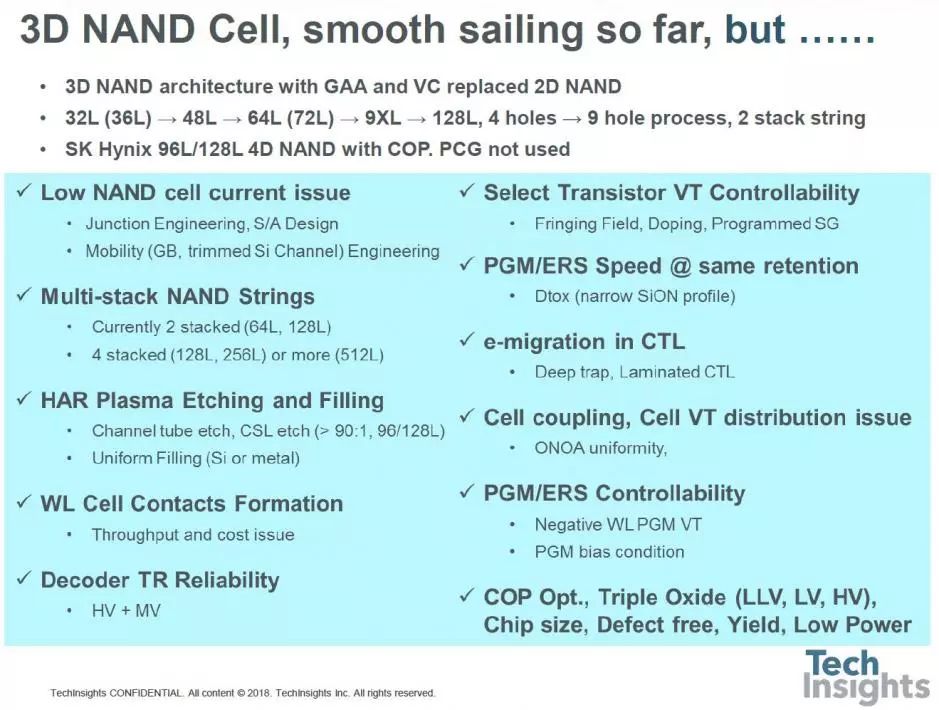
对我来说,值得注意的是SK海力士回归到没有管道栅极的传统堆叠,美光大概会回归到四层堆叠的string,以及蚀刻和填充非常高的宽高比通道的一般问题。
这是一篇很长的文章,所以我将在接下来的第二部分讨论DRAM和新兴存储器。
*免责声明:本文由作者原创。文章内容系作者个人观点,半导体行业观察转载仅为了传达一种不同的观点,不代表半导体行业观察对该观点赞同或支持,如果有任何异议,欢迎联系半导体行业观察。
-

- 半导体行业观察
-

- 摩尔芯闻
最新新闻
热门文章 本日 七天 本月
- 1 OPPO 20周年,首次发布创新与知识产权白皮书
- 2 英特尔重磅发布OPS 2.0,智能教育时代加速到来
- 3 国内首颗,精准纠错!德明利TWSC2985系列:支持4K LDPC技术的存储芯片
- 4 收藏,半导体一些术语的中英文对照